Intel推进混合式 TIM 架构,液态金属×硅基界面材料突破先进封装热阻瓶颈

来源 | SemiVision
在讨论人工智能芯片的热管理挑战时,热界面材料(TIMs)的性能与设计直接决定了热阻以及散热路径的效率。本文将系统性梳理主流 TIM 的分类、物性参数、应用限制,以及 TIM1 与 TIM2 在结构差异和厚度(BLT)上的变化如何影响整体热性能。
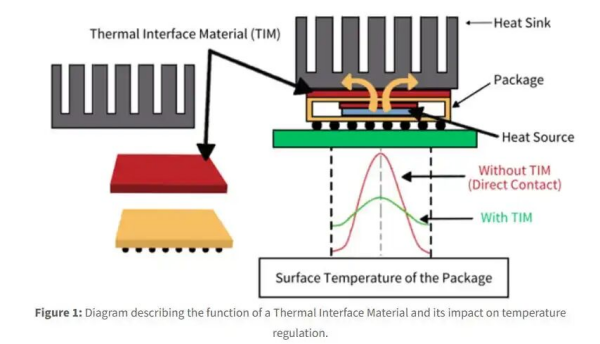
TIM 的角色正在发生根本改变:从以往的被动支撑层,演变为 AI 处理器、高性能计算(HPC)、以及下一代先进封装中的关键稳定性保障。随着芯片功率密度突破 2 W/mm²、本地热点升至超过 100°C、传统散热方案逼近极限,TIM 的选型与设计往往成为决定系统性能和寿命的关键因素。
传统上,人们通过导热率、软硬度或施工便捷程度来简单划分 TIM。但在如今的先进封装体系中,这些维度已远远不够。我们需要同时考量材料的本征导热系数(κ),以及以下因素:
• 压缩状态下的键合线厚度(BLT)
• 与芯片和盖板的有效接触面积
• 界面热阻(Rc)
• 在热循环中的模量稳定性
• 与多轮装配及可靠性测试流程的兼容性
在英特尔的最新研究中,一个混合式 TIM 架构被提出:在中心使用液态金属,在周围区域使用可形变的硅基黏接型 TIM。该设计不再依赖单一材料参数,而是通过热-机耦合仿真建立一种“自补偿”式界面结构。液态金属负责应对峰值热流密度,而低模量的黏接 TIM 则用于吸收翘曲与不平整度;外围采用“围坝”结构控制流动并稳定 BLT。这种架构显著降低了结到壳(Junction-to-Case)的热阻,同时保持翘曲与应力在可靠性范围之内。换言之,散热不再只是“排出热量”——它被纳入系统架构共同设计。

相比之下,台积电(TSMC)的主流策略体现出另一种热管理哲学:依赖成熟的高分子 TIM 与稳定的制造工艺,而英特尔则通过异质材料组合与界面级控制寻求突破。在 CoWoS、InFO、SoW 等平台上,TSMC 已经采用高导热 TIM 并确保 TIM2 到冷板之间的界面稳定。然而,随着功率密度持续攀升,一个问题开始显现:这种“自下而上”的散热模式能否继续扩展?还是我们必须像英特尔一样,从根本上重新思考界面热阻?
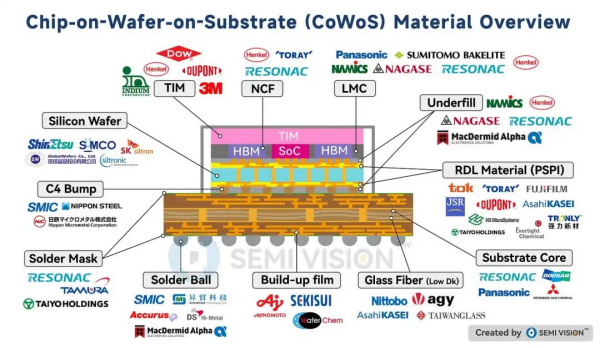
这引出一个更深层的问题:在生成式 AI 工作负载、单台服务器功耗动辄几百至上千瓦的时代,仅仅依靠一款优质 TIM 是否仍然足够?还是我们需要一个系统级的热界面方案——与封装平台、散热模组、乃至液冷系统进行协同设计?
这正是热工程的转折点:从“选择材料”走向“定义架构”。因此,如果你的关注点不再只是如何让芯片堆得更紧、主频跑得更快,而是关心如何让系统在热与机械应力的限制下运行得更久,那么你不应忽视这场由TIM引领的热管理革命。
