北理工张刚团队,电子封装热管理材料最新综述

来源 | Advanced Science
链接 | https://doi.org/10.1002/advs.202524348
01
背景
在电力电子、新能源汽车及航空航天领域,功率器件正朝微型化、高功率密度方向演进,宽禁带半导体发热量剧增,热管理成为性能核心瓶颈。散热路径主要依赖基板(支撑绝缘)与热界面材料(界面传热)。传统基板存在热导率低、热膨胀不匹配或绝缘性差等问题,热界面材料则面临界面热阻高、热稳定性不足等挑战。当前材料开发仍依赖“试错法”,周期长、成本高,难以平衡热性能、可靠性、稳定性与可制造性。亟需开发先进材料体系与智能化设计方法,突破功率电子封装热管理技术瓶颈。
02
成果掠影

近日,北京理工大学张刚团队发表综述,系统总结了功率电子封装热管理材料的最新研究进展,提出了 “材料创新 - 界面工程 - 多尺度模拟 - 智能设计” 的一体化发展范式。该综述聚焦电力电子封装热管理材料的最新进展,核心围绕陶瓷基板(重点为Si₃N₄陶瓷)和热界面材料(TIMs) 两大功能体系展开,系统阐述了通过粉末工程、界面工程、混合填料设计等策略提升材料导热系数、降低热阻、增强机械可靠性的关键技术,同时综述了多尺度模拟与人工智能(AI)/ 机器学习(ML) 在界面传热机制解析、材料筛选优化中的应用,最后指出了材料性能平衡、规模化制备、数据驱动设计等核心挑战,为下一代电力电子封装热管理材料的学术研究与工业应用提供了全面指导。研究成果以“Emerging Advanced Electronic Packaging Materials forThermal Management in Power Electronics” 为题,发表于《Advanced Science》期刊。
03
图文导读

图1. 功率模块中的热管理路径示意图及人工智能辅助材料设计工作流程。
图2. 高性能氮化硅陶瓷的微结构调控策略:(a) 典型烧结后显微组织,呈现 elongated β 晶粒;(b) 通过 α→β 相变及各向异性生长的晶粒演化示意图;(c) 磁场诱导晶体学织构;(d) ZrH₂辅助原位还原及致密化机理;(e) β-Si₃N₄晶种晶须促进的双峰微结构;(f) 不同烧结工艺制备的氮化硅陶瓷热导率与抗弯强度相关性(GPS:气压烧结;SRBSN:烧结反应结合氮化硅;HP:热压;SPS:放电等离子烧结;PLS:无压烧结)。

图3. (a) 高粘度液相阻碍晶粒生长的机理示意图;(b) 不同添加剂用量下氮化硅陶瓷的织构演化机理;(c) 硅热还原处理对氮化硅陶瓷微结构演化影响的示意图;(d) β-Si₃N₄增韧机理示意图。

图4. (a) 应用于氮化硅的机器学习原子间势能迭代再训练框架示意图;(b) 基于机器学习的氮化硅陶瓷热导率迭代优化过程;(c) 陶瓷表面孔隙数据收集流程及机器学习强度预测模型的预测值与实测值对比;(d) 预测热导率的多层人工智能框架概念图,以及通过随机森林回归获得的相对密度与热导率的代表性训练结果。

图5. (a) 金刚石复合热界面材料的类型、性能集成方法及 (b) 典型示意图;(c) 镀钼金刚石/铜复合材料的扫描电镜图像及镀钼金刚石的电子探针显微分析元素分布图;(d) 金刚石/铝界面涂层的扫描电镜图像。

图6. (a) 环氧树脂/纳米金刚石贯穿厚度方向的渗流机理;(b) 氮化硅的微观结构;(c) 制备过程与结构设计示意图;(d) 两种Gradia示意图。

图7. (a) Ti₃C₂/环氧树脂制备流程示意图;(b) P(DMA-HEMA)/VACNT粘附机理示意图;(c) 聚(PBAx-ran-PDMS)嵌段共聚物分子结构示意图;(d) fecO-BNNs形成机理及FeCo/六方氮化硼排列方式示意图。

图8. (a) Ery@SiC、Ery@SiO₂ 和 Ery@Si₃N₄ 的投影态密度;(b) 不同接触面积下(参考体系 Cu-VACNT、Cu-Ni-01-VACNT、Cu-Ni-05-VACNT 及 Cu-Ni-09-VACNT 体系)镍原子的 Cu-Ni-VACNT 体系投影态密度。
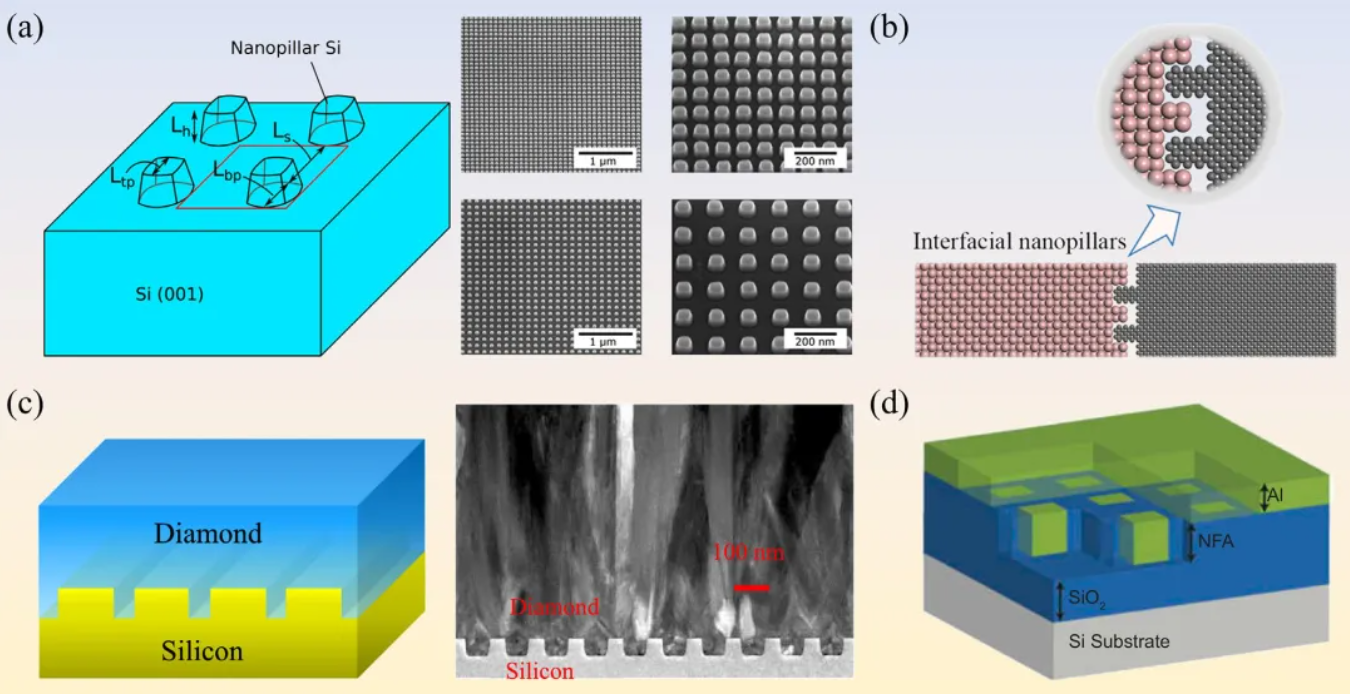
图9. (a) 三维纳米结构阵列界面的示意图及扫描电镜图像;(b) 矩形纳米柱结构界面;(c) 二维矩形界面;(d) 三维矩形纳米阵列界面。

图10. 分子动力学模拟:(a) 纳米铜烧结与拉伸过程中的原子响应;(b) (111)取向纳米孪晶银的分子动力学模型;(c) 不同直径纳米银的烧结过程;(d) Ag₂0Pd纳米合金的烧结扩散行为。

图11. 相场模拟在封装材料开发中的应用:(a) 相场模型中两个序参数的示意图;(b) 直径40纳米的等径银颗粒分别在400°C烧结0、3和15分钟后的形貌;(c) Ag-Cu合金的调幅分解建模;(d) 银枝晶形貌的模拟结果。

图12. 电子封装中的多物理场耦合有限元模拟:(a) 低压封装稳健设计的有限元模拟流程;(b) 热敏感元件气密封装的激光辅助有限元模拟;(c) 电热有限元模拟显示的键合焊盘应力集中区域;(d) IGBT模块设计中的电磁模拟。

图13. (a) 晶体缺陷的有限元与原子联合分析方法示意图;(b) 原子尺度与粗粒化力学的并发粗粒化分子动力学耦合;(c) 含裂纹尖端自适应加密及约束耦合粗细网格的相场-有限元框架;(d) 采用动力学蒙特卡洛模拟与相场法对α-Fe中富铜析出相的粗化动力学分析;(e) 多尺度多物理场建模范式;(f) 基于聚合物热界面复合材料的数据驱动工程工作流程。

