中南大学团队,铟基 TIM 突破 FCBGA 封装散热瓶颈

来源 | Materials Science in Semiconductor Processing
链接 | https://doi.org/10.1016/j.mssp.2025.110314
01
芯片散热卡脖子?铟基 TIM 的 “表面魔法” 破解封装难题
随着电子设备向高集成、高功率密度演进,散热可靠性成为决定器件性能与寿命的关键。在 FCBGA 封装中,铟基热界面材料(TIMs)凭借 82 W/(m・K) 的高导热性和优异延展性,成为理想选择。但实际应用中,芯片背面 Ti/Ni/Au 多层金属化结构里,超薄金层难以完全阻挡镍氧化,不仅会破坏铟的润湿性,还会导致界面金属间化合物(IMC)生长不均,产生空隙缺陷,严重影响散热效率与连接可靠性。传统解决方案或成本高昂,或难以应对多次高温回流后的性能衰减,如何通过简单有效的表面处理,让铟基 TIMs 稳定发挥散热潜力,成为封装行业亟待突破的难题。
02
成果掠影

近日,中南大学朱文辉教授、汪炼成教授团队针对 FCBGA 封装中铟基热界面材料(TIMs)的应用痛点,提出氩氢(Ar+H₂)等离子体表面处理技术,核心成果如下:
·润湿性大幅提升:经九次高温回流后,铟基 TIM 在芯片表面的铺展率达 112.7%,较未处理样品提升 25.7%,且表面能从 28.25 mN/m 增至 72.50 mN/m,实现超亲水特性。
·界面质量显著优化:诱导形成均匀的(Ni, Au)₂₈In₇₂金属间化合物(IMC)层,root 均方粗糙度低至 0.44 μm,有效削弱 “钉扎效应”;Lid/In/BSM 三明治结构中,空隙率仅 1.1%,较未处理样品降低 39%。
·热可靠性稳步增强:热仿真显示,该处理使芯片峰值温度较纯氩等离子体处理样品降低超 45%,无论水溶性还是免清洗助焊剂体系,均能满足高可靠性封装的空隙率要求(平均 < 5%、最大单空隙 < 0.5%)。
·工业适用性强:工艺与现有封装生产线兼容,无需额外改造,为铟基 TIM 在 FCBGA 封装中的规模化应用提供了可行技术路径。
研究成果以“Influence of argon hydrogen plasma treatment on the wettability, void and high temperature reflow reliability of indium thermal interface material for FCBGA package” 为题,发表于《Materials Science in Semiconductor Processing》期刊。
03
图文导读
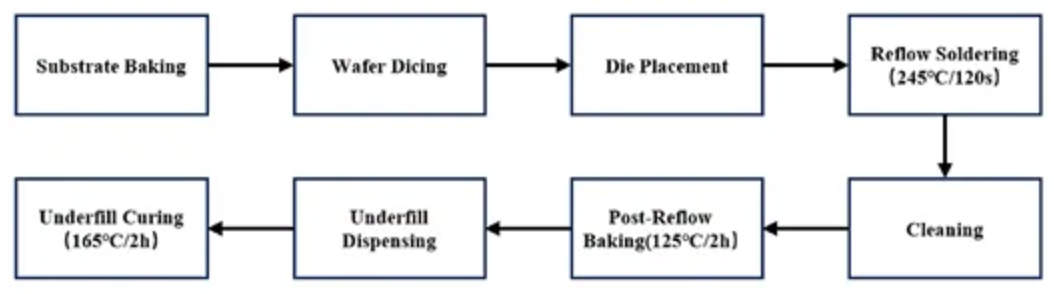
图 1:BSM 芯片与铟热界面材料焊接前的工艺流程
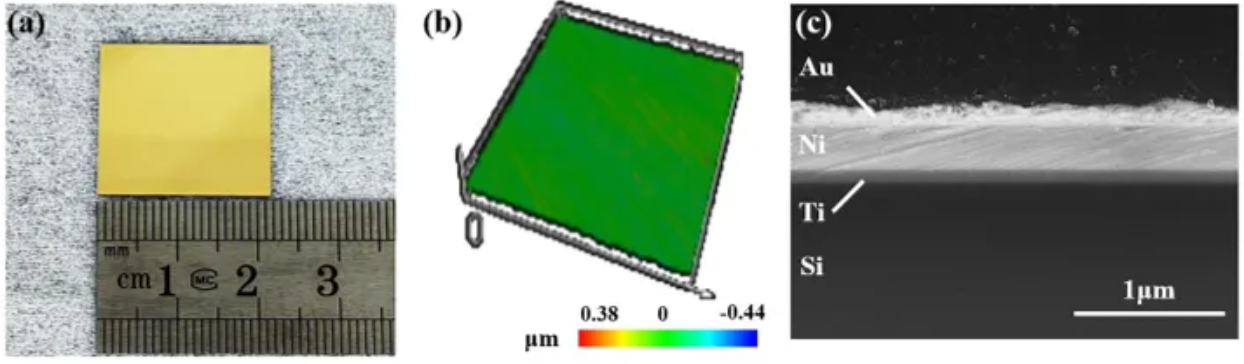
图2:热处理后 BSM 芯片的特性:(a) 宏观表面形貌;(b) 三维表面形貌;(c) 截面 SEM 图像

图3:热处理后 BSM 芯片镀层的元素分布
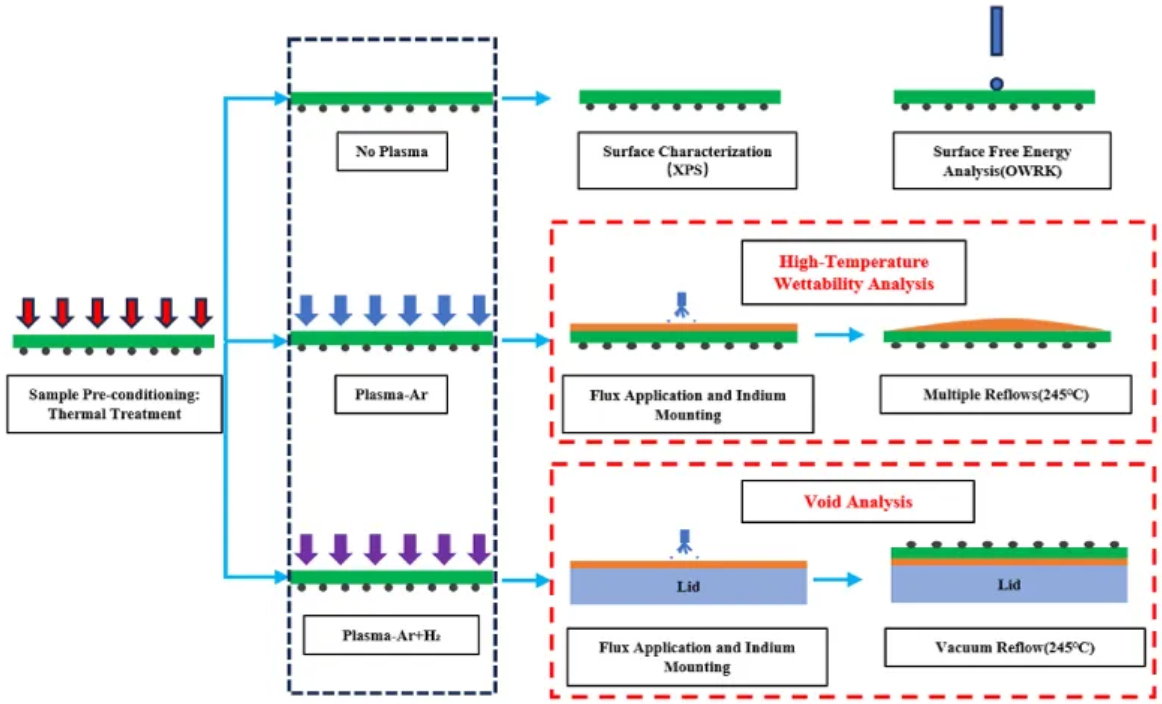
图4:不同等离子体处理样品的分析流程
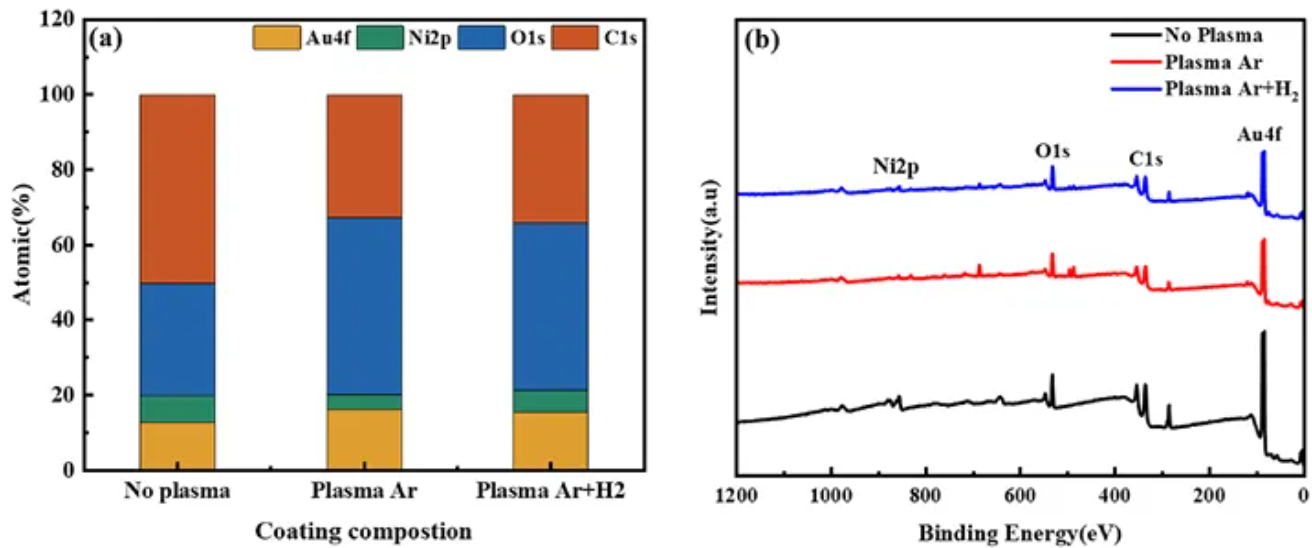
图5:不同表面处理的元素组成比例及 XPS 全谱图:(a) 元素组成;(b) XPS 全谱

图6:不同表面处理的 XPS 谱图:(a) Au 4f 谱图;(b) Ni 2p 谱图;(c) O 1s 谱图;(d) C 1s 谱图

图7:不同表面处理的表面性能:(a) 接触角;(b) 表面能(含极性分量与色散分量)

图8:不同表面处理后 BSM 芯片镀层的 SEM 图像:(a)-(a-i) 无等离子体处理样品;(b) (a-i) 中 1 号位置的 EDS 元素分析;(c)-(c-i) Ar 等离子体处理样品;(d)-(d-i) Ar+H₂等离子体处理样品

图 9:不同表面处理后 BSM 芯片镀层的颗粒尺寸分布直方图及累积频率曲线:(a) 无等离子体处理;(b) Ar 等离子体处理;(c) Ar+H₂等离子体处理

图 10:水溶性助焊剂体系下不同表面处理样品的铺展形貌光学显微镜图像:(a-i)-(a-iii) 无等离子体处理样品(1/3/9 次高温回流后);(b-i)-(b-iii) Ar 等离子体处理样品(1/3/9 次高温回流后);(c-i)-(c-iii) Ar+H₂等离子体处理样品(1/3/9 次高温回流后)

图 11:免清洗助焊剂体系下不同表面处理样品的铺展形貌光学显微镜图像:(a-i)-(a-iii) 无等离子体处理样品(1/3/9 次高温回流后);(b-i)-(b-iii) Ar 等离子体处理样品(1/3/9 次高温回流后);(c-i)-(c-iii) Ar+H₂等离子体处理样品(1/3/9 次高温回流后)
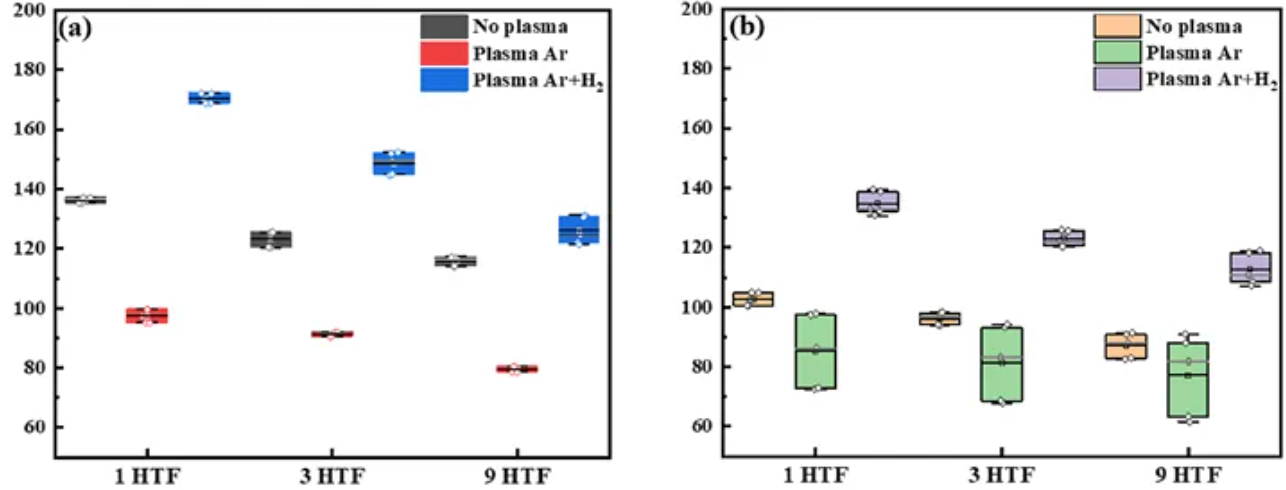
图 12:不同表面处理样品在不同助焊剂体系下的铺展率演变:(a) 水溶性助焊剂样品;(b) 免清洗助焊剂样品
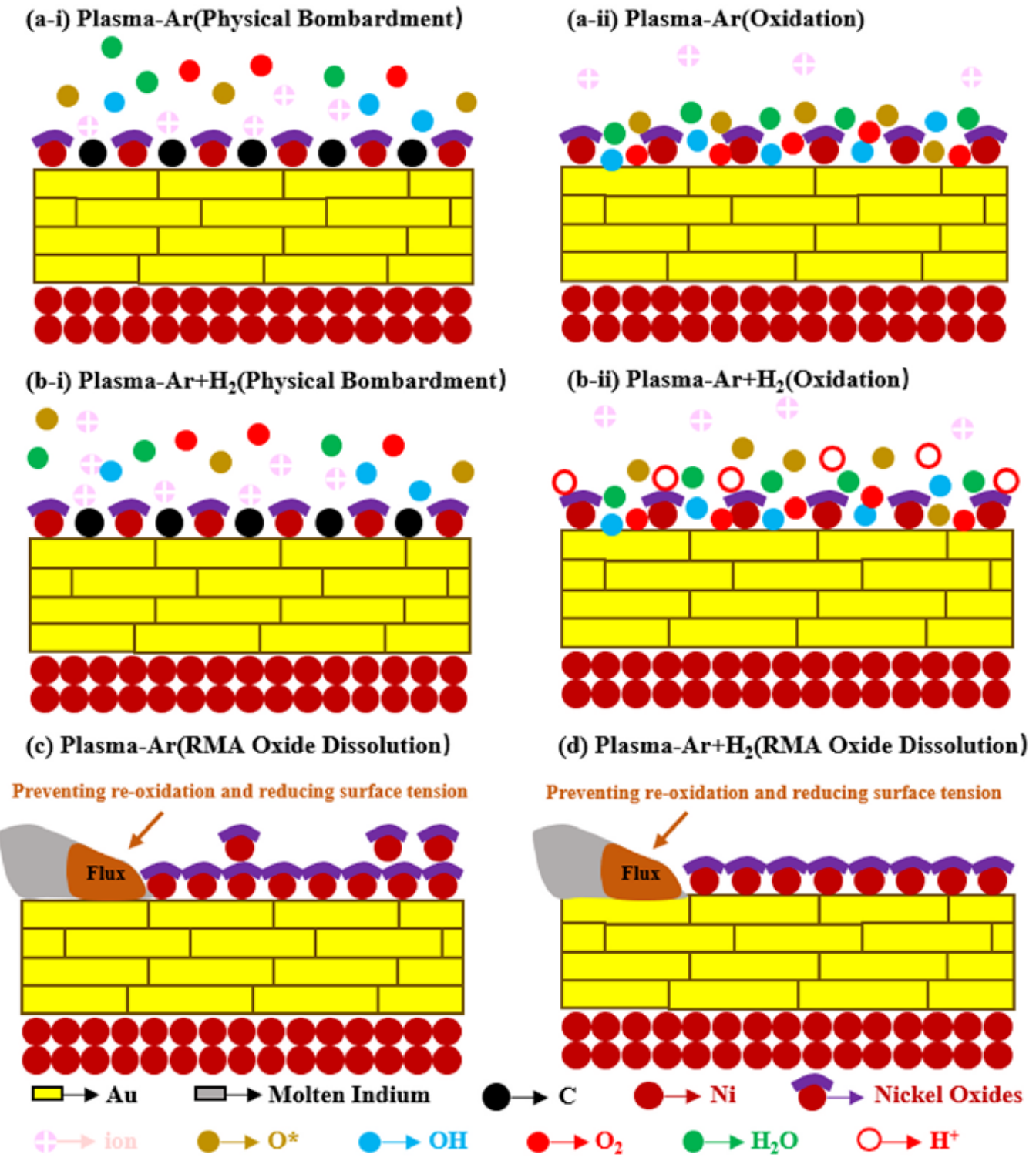
图 13:等离子体作用与助焊剂行为示意图:处理后镀层改性及氧化物去除机制(a-i) Ar 等离子体(物理轰击);(a-ii) Ar 等离子体(氧化作用);(b-i) Ar+H₂等离子体(物理轰击);(b-ii) Ar+H₂等离子体(氧化作用);(c) Ar 等离子体(助焊剂氧化物溶解);(d) Ar+H₂等离子体(助焊剂氧化物溶解)

图 14:1 次高温回流后样品界面的 IMC(金属间化合物)形貌
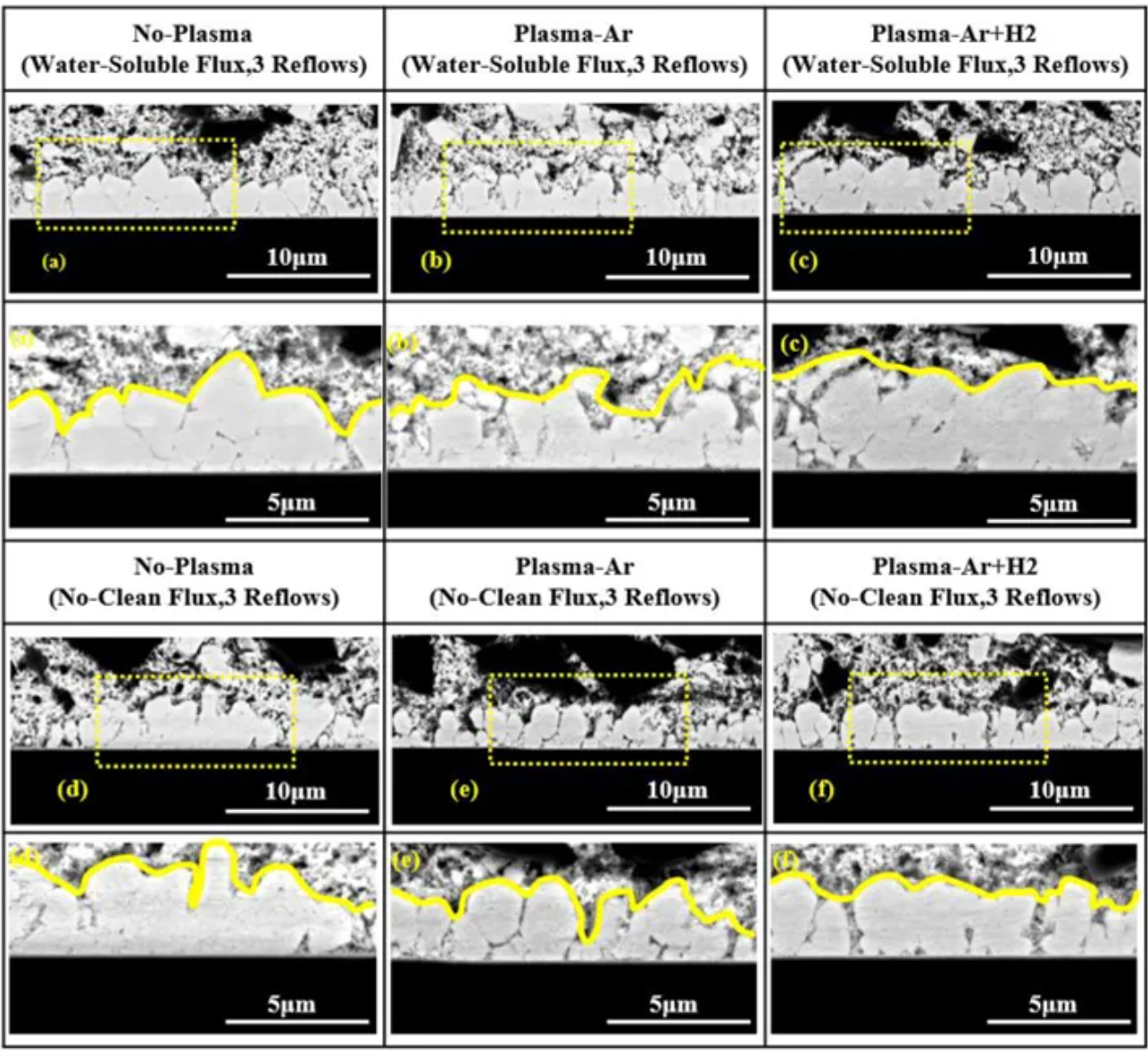
图 15:3 次高温回流后样品的截面微观结构:(a) 水溶性助焊剂体系 - 无等离子体处理;(b) 水溶性助焊剂体系 - Ar 等离子体处理;(c) 水溶性助焊剂体系 - Ar+H₂等离子体处理;(d) 免清洗助焊剂体系 - 无等离子体处理;(e) 免清洗助焊剂体系 - Ar 等离子体处理;(f) 免清洗助焊剂体系 - Ar+H₂等离子体处理

图16:3 次高温回流后样品的 IMC 特征参数统计:(a) 平均厚度;(b) 均方根粗糙度(Rrms);(c) 平均间距(λave)

图17:9 次高温回流后样品芯片区域的 X 射线图像
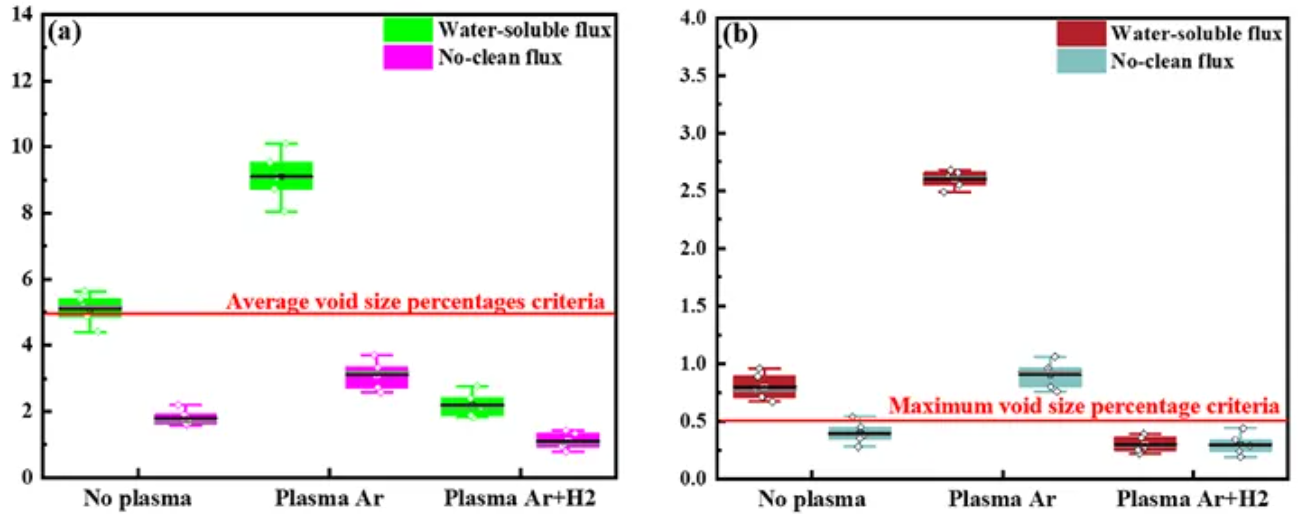
图18:不同表面处理样品在不同助焊剂体系下的空隙率:(a) 平均空隙率;(b) 最大空隙率
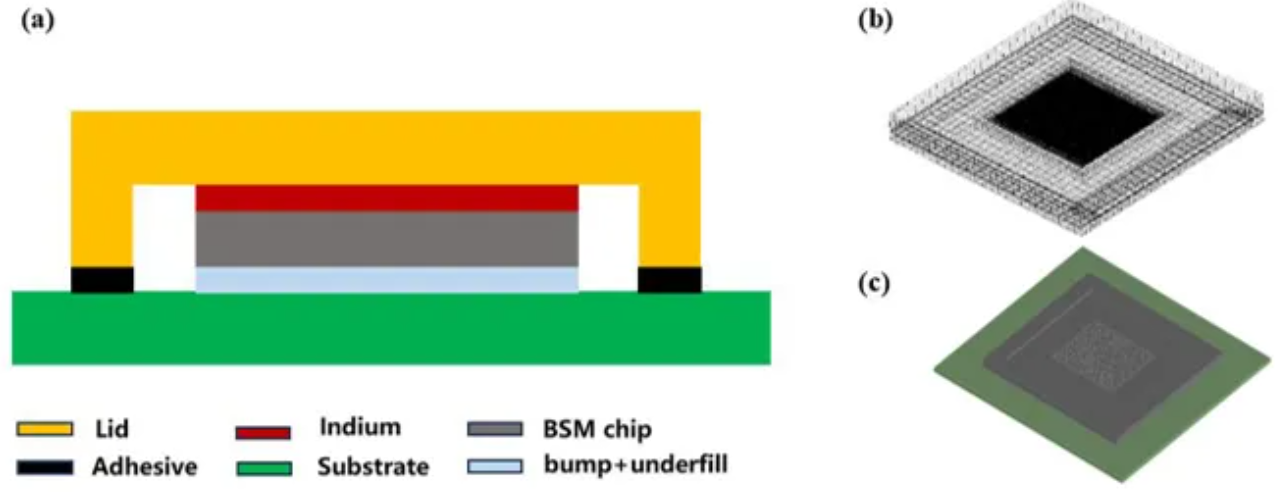
图19:封装结构与仿真模型:(a) 封装截面材料层;(b) 网格划分后的计算模型;(c) 封装三维结构示意图

图20:9 次高温回流后样品芯片区域的温度场分布
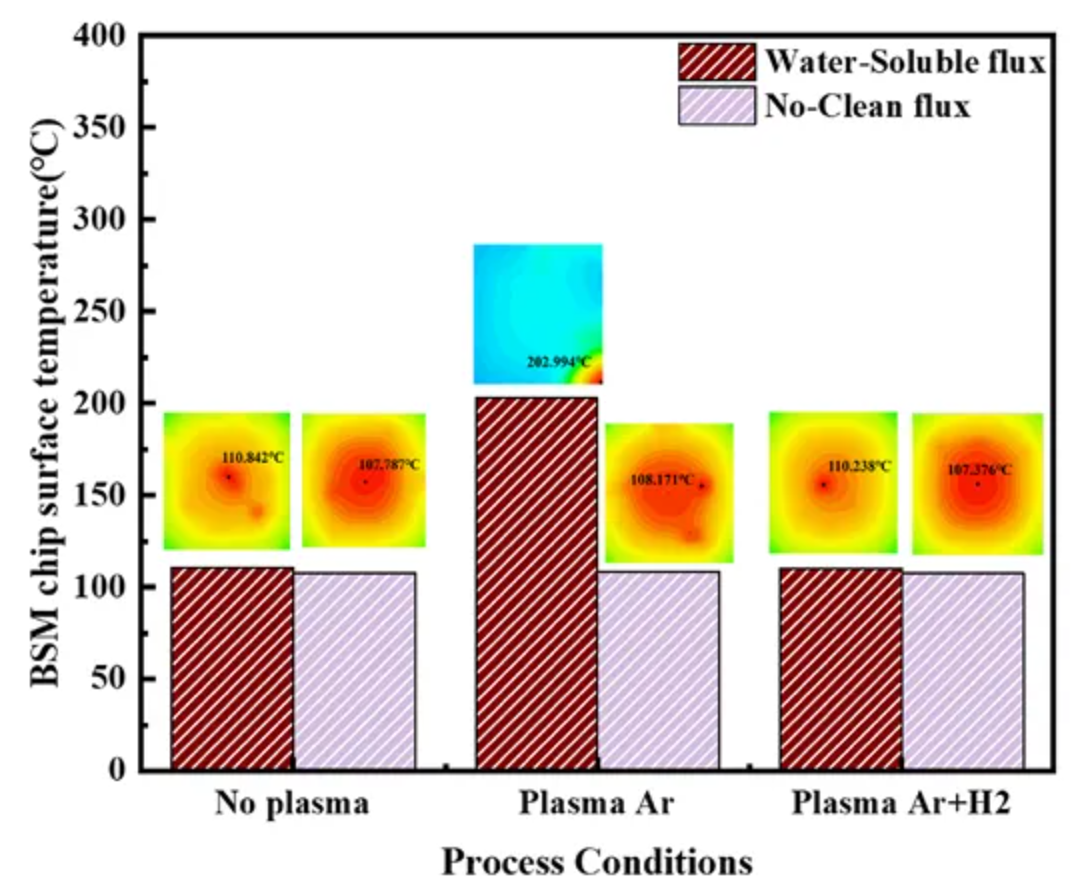
图21:9 次高温回流后样品芯片表面的温度对比

