电子设备降温关键!热界面材料技术全景与未来方向

来源 | Applied Thermal Engineering
链接 | https://doi.org/10.1016/j.applthermaleng.2025.129415
01
电子设备 “降温危机” 如何破解?这款关键材料成突破口
在消费电子与高端制造领域,“更小、更快、更强” 早已成为技术演进的核心命题 —— 笔记本电脑机身薄至 15mm 以下,5G 基站芯片运算速率较 4G 提升 10 倍,电动汽车功率模块能量密度突破 300Wh/kg。然而,性能跃迁的背后,是一个日益严峻的 “隐形障碍”:热量堆积。当晶体管尺寸从微米级缩小至纳米级,电子设备的功率密度呈指数级攀升,部分高性能处理器的热流密度已突破数百 W/cm²,相当于在指甲盖大小的面积上,持续释放着堪比家用燃气灶的热量。若这些热量无法及时疏导,轻则触发 “thermal throttling( thermal throttling)”—— 设备主动降频以保护硬件,导致卡顿、延迟;重则造成材料降解、焊点脱落,甚至引发芯片永久性损坏,直接缩短设备寿命。
在这一背景下,热界面材料(Thermal Interface Materials, TIMs) 成为了电子设备热管理系统中的 “关键桥梁”。看似光滑的芯片与散热器表面,在微观视角下实则布满凹凸不平的 “沟壑”,空气或真空填充其中,形成巨大的热阻屏障。而 TIMs 的核心作用,正是通过填充这些界面空隙、增大实际接触面积,将发热元件(如处理器、功率模块)与散热结构(如散热器、均热板、液冷系统)紧密连接,大幅降低热阻,实现高效热传递。
随着技术场景不断拓展,TIMs 的性能需求也在持续升级。在高算力数据中心,AI 服务器 24 小时满负荷运行,需要 TIMs 具备长期稳定性,避免因 “干涸” 或 “泵出效应” 导致热阻上升;在新能源汽车领域,SiC(碳化硅)、GaN(氮化镓)功率模块需耐受 - 40℃至 150℃的极端温度循环,对 TIMs 的机械柔韧性与耐候性提出严苛要求;而在可穿戴设备、折叠屏手机等小型化产品中,TIMs 还需兼顾超薄形态与柔性适配能力。
传统 TIMs 如导热硅脂、相变材料(PCMs)虽能满足中低功率场景需求,但在高功率密度、长周期运行条件下逐渐力不从心 —— 硅脂易因高温流失,PCMs 自身导热系数偏低,难以应对瞬时热冲击。为此,科研界正将目光转向纳米材料与复合结构:碳纳米管(CNTs)阵列的轴向导热系数可达 3000W/mK,石墨烯基复合材料兼具高导热与柔性,垂直排列的金属纳米线则能构建高效热传导路径。这些创新方向,不仅旨在突破传统材料的性能瓶颈,更试图通过 “界面工程”“混合架构设计” 等策略,同步解决热导率、机械兼容性与环境稳定性的多重挑战。
02
成果掠影

近日,Jaypee Institute of information and technology的Narinder Kaur团队本文聚焦电子设备热管理痛点,指出器件微型化导致功率密度攀升(部分处理器热流密度超数百 W/cm²),热量堆积引发设备降频、寿命缩短,而热界面材料(TIMs)作为连接发热元件与散热结构的关键,通过填充界面空隙降低热阻是破解热瓶颈的核心;传统 TIMs 各有适用场景,导热硅脂成本低、易涂覆但长期易干涸,相变材料(PCMs)善缓冲瞬态热冲击却需纳米填料提导热性,导热胶带操作便捷但导热率低,金属基 TIMs 导热极高却易氧化、成本高,陶瓷基 TIMs 兼具绝缘与耐高温却较脆;纳米材料突破传统性能天花板,碳纳米管(CNTs)轴向导热率超 3000W/m・K,石墨烯导热率 2000-5000W/mK 且柔性好,Cu 纳米线低占比即可大幅提升环氧树脂导热率,还可通过 “高导热网络 + 柔性粘结剂 / 相变层” 混合设计平衡性能,界面工程优化效果优于单纯提本体导热率;未来需开发 2D 材料(MoS₂、h-BN)、金刚石 - 石墨烯杂化物及可降解纳米纤维素 TIMs,强化 TIMs 抗热循环可靠性,推动无溶剂制备等产业化技术,用分子动力学、机器学习加速研发,最终通过多维度协同突破热阻、稳定性与成本约束,支撑下一代电子设备发展。研究成果以“Thermal Interface materials for efficient heat management in electronics” 为题,发表于《Applied Thermal Engineering》期刊。
03
图文导读

图 1:(a) 电子设备热管理示意图(b) 热阻网络示意图(c) 热界面材料(TIM)的分子模型(以聚合物基热界面材料为代表)
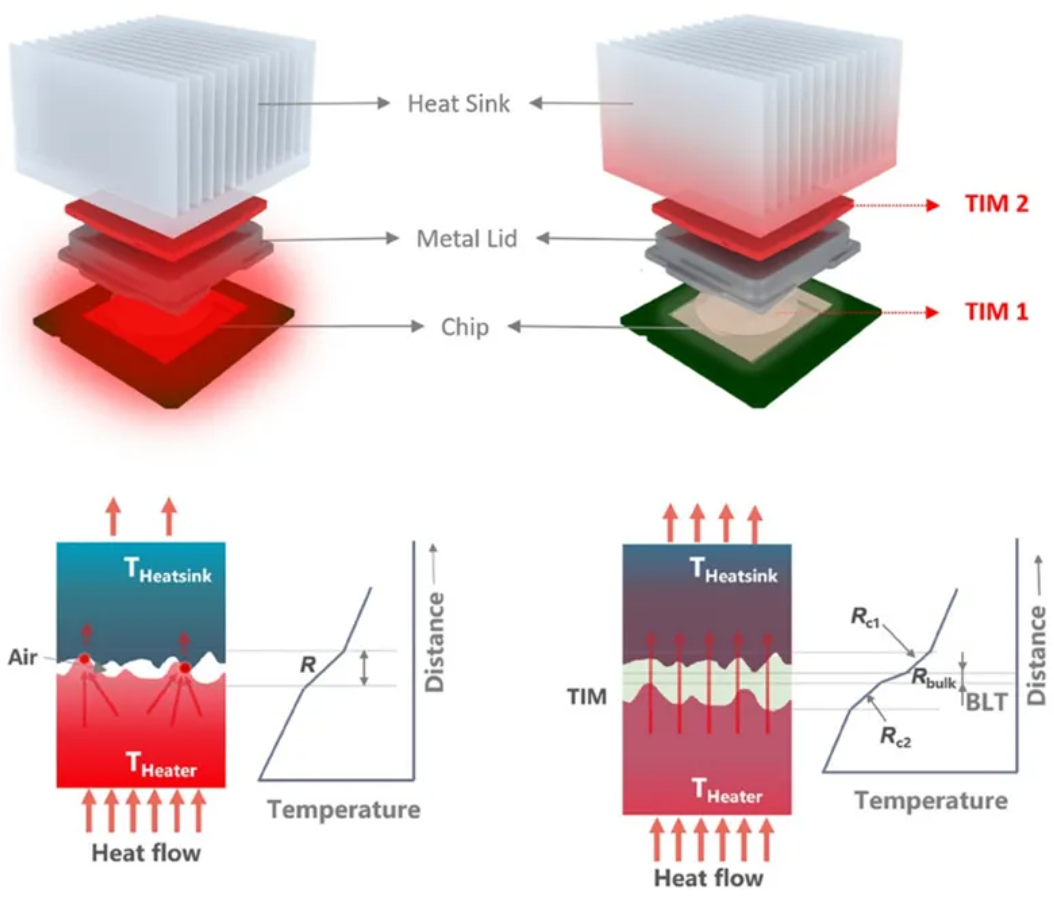
图 2:左侧:未使用热界面材料时的散热示意图(标注 “Air R” 表示空气热阻、“Ra” 表示表面粗糙度、“Distance” 表示间距、“THeater” 表示发热体温度、“THeatsink” 表示散热器温度)右侧:使用热界面材料(TIM)促进电子设备散热的示意图(标注 “TIM1”“TIM2” 分别表示不同位置的热界面材料、“BLT” 表示热界面材料厚度)

图 3:(a) 材料制备过程示意图(标注 “POE”“BD” 为材料缩写,具体需结合上下文,可能指聚烯烃、丁二烯等)(b) 材料制备原理示意图(c) 相变型热界面材料(PCTIMs)填充粗糙表面以降低接触热阻的示意图

图 4:(a) 不同复合材料的结构示意图(从左至右:GOPVDF-HIPDMI 复合材料、GO-PVDF-HIFP 复合材料、rGO-PVDF-HIFP 复合材料,“GO” 指氧化石墨烯、“PVDF” 指聚偏氟乙烯,其余为功能基团缩写)(b) 材料制备流程示意图(从左至右:等离子体处理 SiC 纳米棒、SiO₂纳米颗粒修饰石墨烯纸(GHP)的过滤 - 退火 - 快速制备过程、Ag 纳米颗粒修饰细菌纤维素(AgNPs@BC)的过滤制备过程、石墨烯纳米片(GNPs)与 Al₂O₃的复合过程)(c) 石墨烯基材料的不同结构示意图(从左至右:石墨烯纸、褶皱石墨烯、石墨烯块体,标注 “MN”“Shrinking”“Compressing” 分别表示微纳结构、收缩工艺、压缩工艺)

