21.0W/mK!一种用于FCBGA封装的碳纤维导热垫
来源 | Microelectronics Reliability
链接 | https://doi.org/10.1016/S1872-5805(25)60964-4
01
背景介绍
倒装芯片球栅阵列(FCBGA)是当前CPU和GPU的主要封装形式。随着人工智能芯片的小型化和智能化,FCBGA芯片的功耗持续增加(H100的功耗已超过800瓦),散热问题变得日益严重。在整个芯片的散热系统中,热界面材料(TIM)的热导率是限制FCBGA封装散热能力提升的关键瓶颈。目前商业化的TIM,如X-23,其热导率为3.8至6 W/mK,不足以应对现有FCBGA的高散热需求。
02
成果掠影

近日,中南大学汪炼成、朱文辉团队将定向碳纤维引入硅油基体中,制备了一种热导率为21.0W/mK的导热垫,并将其作为FCBGA封装中的TIM1使用。通过优化包括盖板附着、切割锯和封装结构设计在内的关键工艺,封装后的覆盖率达到了88.22%。热仿真表明,将FCBGA中的TIM从X-23替换为自制导热垫后,结温(Tj)从69.9摄氏度降低到66.8摄氏度。此外,还对采用碳纤维导热垫作为TIM的FCBGA封装进行了可靠性测试。研究成果以“Investigation on FCBGA package with vertical-aligned carbon fiber thermal pad as thermal interface material”为题发表在《Microelectronics Reliability》期刊。
03
图文导读

图1. 以碳纤维导热垫作为热界面材料的FCBGA封装工艺示意图。

图2. a, b) 导热界面材料中碳纤维填料的形态,分别以低分辨率和高分辨率显示;c, d) 由碳纤维填料组成的导热界面材料的形态,分别以低分辨率和高分辨率显示;e, f) 导热界面材料中的碳纤维填料。

图3.不同切割方法后导热界面材料的SEM形态。a) 使用切割锯切割后的横截面形态;b) 使用刀片切割后的横截面形态;c) 使用离子束切割后的横截面形态;d) 使用离子束切割后的横截面形态的高分辨率图像。
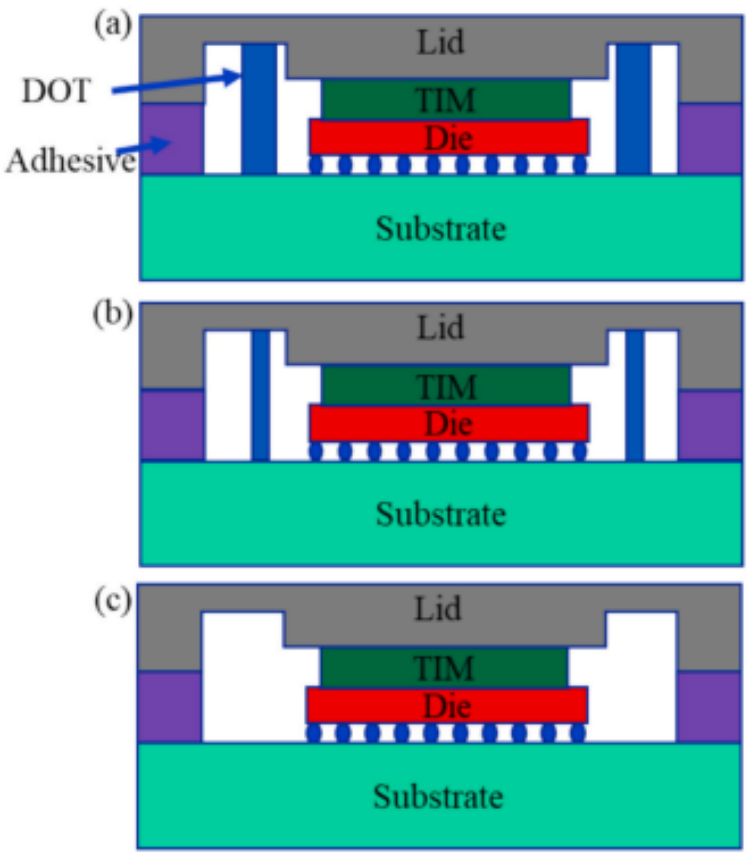
图4.a) 样品1,b) 样品2和c) 样品3的封装结构示意图。
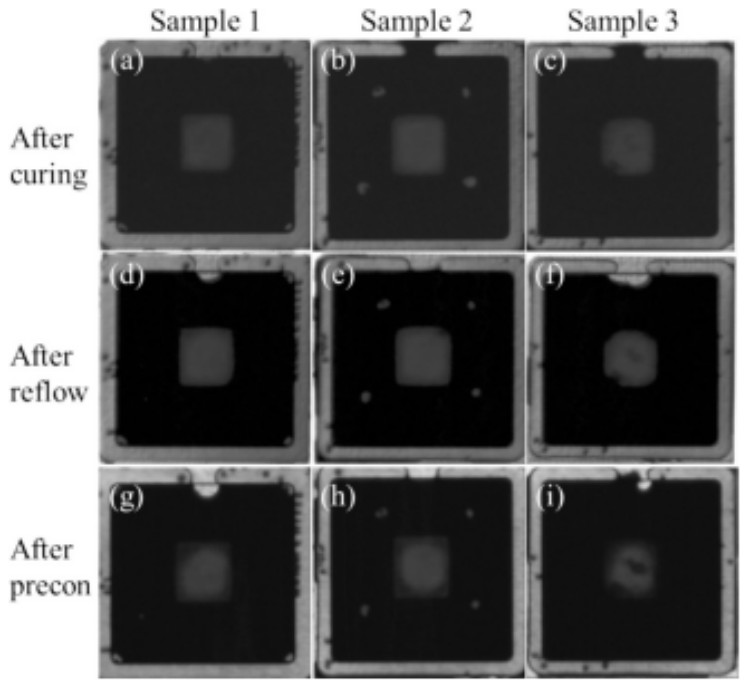
图5.样品1、2和3在固化过程(a-c)、回流过程(d-f)和预热过程(g-i)后的FCBGA封装扫描图。

图6.a) 不同样品的盖板和基板翘曲,b) 不同样品的芯片区域盖板和基板翘曲,c) 30°C和d) 260°C下由FCBGA翘曲引起的分层示意图。
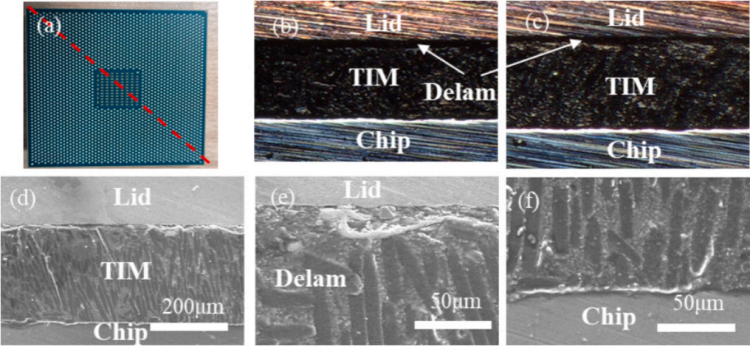
图7.a) 钻石刀切割路径示意图;b-c) 样品3的OM横截面图像;d-f) 样品3的SEM横截面图像。
