陶文铨院士:阶梯式微通道冷板,CPU散热新方案!
来源 | International Journal of Heat and Mass Transfer
链接 | https://doi.org/10.1016/j.ijheatmasstransfer.2025.127060
01
背景介绍
随着互联网产业的快速发展,芯片的使用越来越广泛,尤其是对于CPU、GPU以及其他行业中的IGBT芯片。随着芯片制造工艺的进步、芯片核心数量的增加以及芯片工作频率的提高,CPU芯片的散热需求也在不断上升。随着CPU热设计功耗(TDP)突破385W,传统风冷已无法满足100W/cm²以上的散热密度需求。微通道冷板虽能处理高热通量,但现有研究多简化芯片为均匀热源,忽略真实CPU封装的多层结构(芯片/TIM/IHS/PCB等),导致设计偏差。
02
成果掠影

近日,西安交通大学陶文铨院士团队提出一种商用CPU封装耦合冷却新方案,通过阶梯式微通道冷板实现CPU超强散热。团队通过对比Z型、U型、I型三种入口流道,发现I型流道性能表现最佳。增加微通道层数(MCLN)可降低流阻,但MCLN>5时出现无效通道,MCLN=9时压力降降低94.8%(仅37.51 Pa),MCLN=5时综合最优。随后,团队提出了一种阶梯式结构创新——基于I型9层冷板切除低温区通道(I-type-9L-CUT1),I-type-9L-CUT1的CPU功耗达278.48W,压力降仅523.46 Pa。此外,团队将I-type-9L-CUT1的热界面材料TIM2进行升级,用铟替代硅脂,热导率从5 W/mK提高到86 W/mK,CPU功耗再提升58.2W,具有最高的MPCPU和最低的热阻。最后,优化后的I-type-9L-CUT1冷板在0.3825 L/min流量下,CPU芯片平均热通量达206.5 W/cm²,压力降为523.5 Pa,泵功仅3.337 mW。研究成果以“Heat transfer and pressure drop characteristics of microchannel cold plate in commercial CPU-package cooling system”为题发表在《International Journal of Heat and Mass Transfer》期刊。
03
图文导读
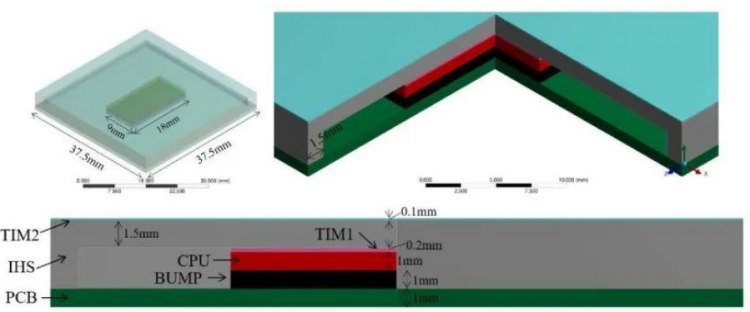
图1.CPU封装的几何结构。

图2.耦合CPU封装的前视图。
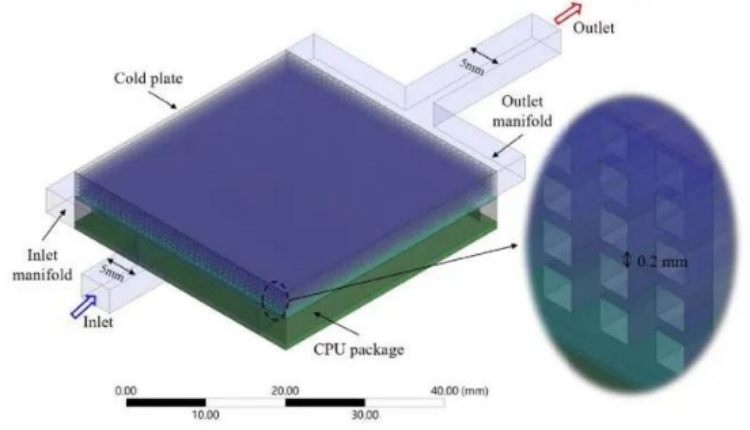
图3. “I-type-5L”CPcCPU几何结构的等轴测视图。
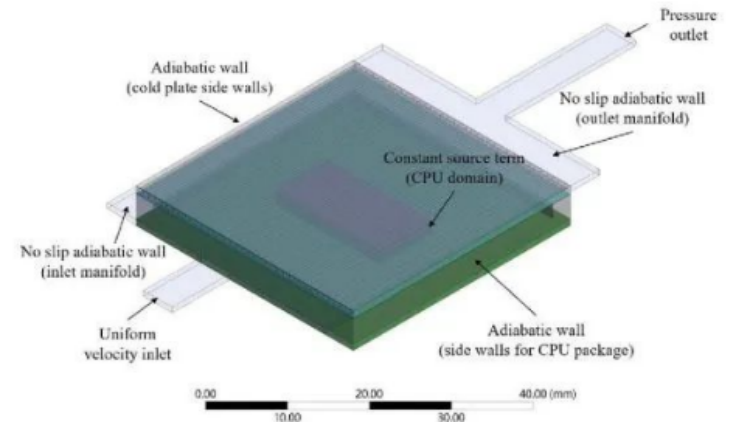
图4.CPcCPU的计算域和边界条件。

图5.三种类型歧管(Z型、U型和I型)的CPcCPU温度云图和速度大小云图。

图6.不同MCLN下I型CPcCPU在X和Z坐标中间截面的温度云图。
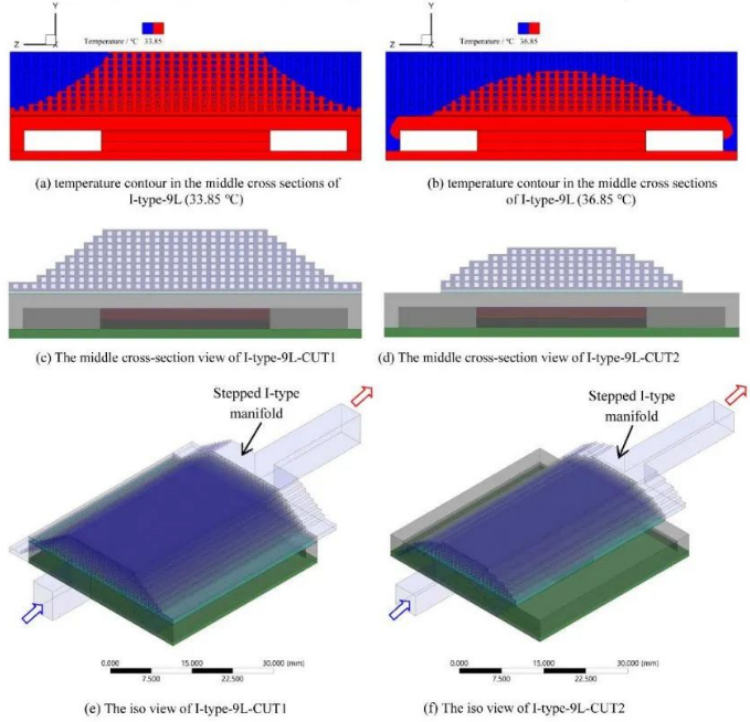
图7.基于I-type-9L的阶梯式多层微通道冷板设计过程。
