微通道冷板技术路线图:下一代 GPU 散热路线图【收藏】

2025年这一年全球各大AI厂商的仍然在加大资本开支,可以看到国内外大厂在AI领域的新进展以及重大投资收购的动态,厂商对算力的需求仍旧激增不下。用于训练的大模型的核心的数据中心领域25年的收并购频发,再到算力芯片领域除英伟达之外,谷歌、AMD、Intel等厂商也都持续的发力AI芯片。
从这次的CES2026我们也能看到AMD的未来布局。此外芯片厂商挤破脑袋向台积电抢先进制程和封装的产能,包括用于存储芯片的厂商(美光、三星、海力士)为了这块高附加值的HBM、DRAM5的高附加值产品,将一些传统芯片的产能做了调整,存储芯片的价格也飞上了天。
老马也没闲着,在社交平台上透露即将亲自下场投资一个2nm的Fab,Tesla目前的业务来看除了近两百万辆搭载AI5芯片的特斯拉车之外还有全球最大的超算集群Colossus,对于芯片的需求可能远超供应商所能提供的产能分配。
产业链的每一环都离不开之间的协作发展,但是这一年“AI”仍然是一个热点的话题,不论是硬件、软件、芯片等等环节,好像AI已经开始慢慢再渗透我们物理世界的每一个环节。
01
关于“微通道”液冷板
今天我们就关于AI数据中心的算力芯片热管理做个回顾和讨论,在25年的Q2,一则新闻打破了数据中心热管理领域的平静。据报道英伟达的Rubin与下一代的Feynman平台的功耗预期将突破2kW,现有传统的冷板可能无法满足这一要求,因此向供应商提出了开发全新“微通道水冷板(MLCP)”技术。这一消息引爆了产业链的预期。另外据台湾产业链的消息,已有公司向英伟达送样MLCP,但业内人士表示,MLCP并不是唯一的解决方案,多个新型散热方案仍在并行验证中。

这一消息出来“微通道液冷板”成为了25年的热词,这一关键的转折点让液冷组件从大家所认熟知的“精密五金件”可能会升级为“芯片级的精密微纳器件”,由此未来可能会引发新一轮的产业链的重构。可以想象当冷板接近die的时候,那怕是die的背面那也将会对于冷板的要求将会有质的飞跃,以及冷板洁净度、以及流体、杂质等等都会出现更严苛的标准,供应链的配合也许会发生新一轮的变革。
02
关于微通道液冷板最新动态
在刚刚结束的CES2026上英伟达提前公布了Vera Rubin NVL72机架以及Compute Tray,并且宣布正式推出最新的Rubin平台已经量产。预计在2026年3月的GTC大会上应该就能看到VR 200NV72的完全体。这一次英伟达对Vera Rubin Compute Tray进行了重新设计,旨在简化极其复杂的组装过程。

Rubin 实现了从前代约 80% 液冷到100%全液冷的转变,底盘内部彻底取消了风扇;节点内部从前代的43根电缆减少到0根电缆,取而代之的是6根液冷管道;由于取消了复杂的电缆连接,单个节点的组装时间将大幅缩短,且极大降低了误操作风险;
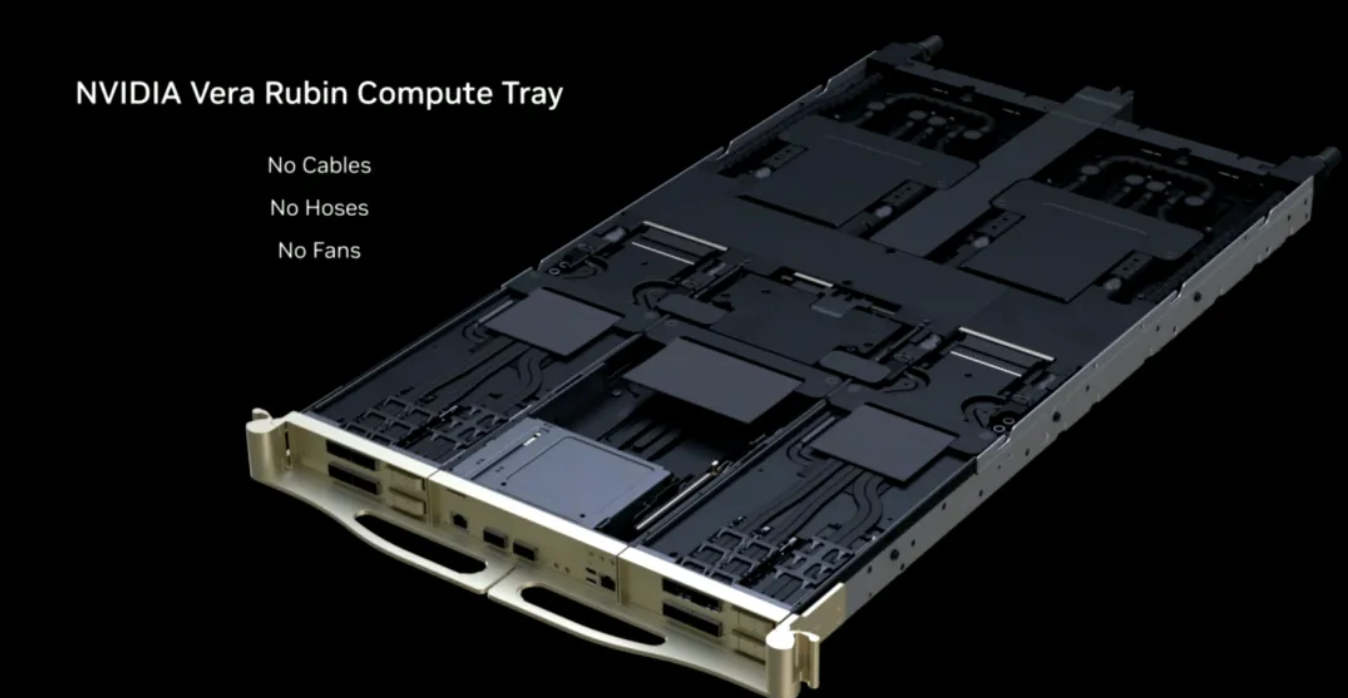
Rubin的功耗是 Grace Blackwell 的2倍,但其液冷系统依然可以使用 45°C 的温水进行冷却。由于可以使用 45°C 的温水,数据中心不再需要昂贵且耗能的制冷机组。这种极其高效的液冷架构预计能够节省全球数据中心约 6% 的电力。

就在老黄演讲完第二天知名分析师郭明錤发文称英伟达新一代 Rubin 架构(VR200 NVL72)在散热体系上出现关键性代际跃迁。同时也提到了采用NVL72而没有NVL144,但是会提供Max Q/P两个版本;两个版本的TGP和TDP分别是1.8/190(KW)和2.3/230(KW)的规格。

根据披露Rubin GPU 将率先在旗舰级算力平台上采用微通道冷板(MCCP)+ 镀金散热盖(gold-plated lid)的组合方案,这意味着微通道技术被正式确立为高端 AI 服务器的主流散热形态,而市场高度期待的、将液冷结构直接集成进封装盖板内部的微通道盖板(MCL,封装级液冷),最快仍需到 2027 年下半年才进入量产阶段,Rubin更像是从板级液冷迈向封装级液冷的关键过渡平台。
03
关于传统液冷板以及芯片热管理介绍
芯片级散热技术一般可分为三种类型:
·远端冷却架构(Remote Cooling Architecture):芯片通过两层热界面材料(TIM)将热量传导到热沉或冷板。该方式是传统的远端散热方案,但随着芯片功率密度增加,其散热能力逐渐受限。
·近芯片冷却架构(Near-Chip Cooling Architecture):为应对功率密度和芯片面积增加带来的散热压力,近芯片冷却架构直接将芯片通过一层TIM与热沉或冷板贴合,减少了中间的热阻层,从而提升可冷却的热流密度。相比远端冷却,这种方式能够更高效地传导热量,提高芯片整体散热性能。
·芯片内嵌冷却架构(Embedded On-Chip Cooling Architecture):通过消除芯片与热沉之间的TIM,在芯片衬底上刻蚀微通道,并引入流体冷却介质,实现直接内部散热。此方式能够将热量从芯片核心快速带走,是应对高功率密度芯片的先进散热方案。
当 GPU 功耗正式迈入 2kW+ 区间,传统铲齿毫米级流道冷板的换热能力可能会触及上限,从产业路线看当前液冷板正沿着“通道微缩化—结构内嵌化—封装一体化”三条技术主线同步推进,并逐步形成三代核心技术范式。当前传统的冷板式液冷的方案(远端冷却架构),典型的传热路径(如下图所示)包括:硅衬底本身、金属互连层、TIM1(通常为铟或石墨材料)、封装盖板(Lid)、TIM2(如石墨片或超薄导热膏),以及最终的散热器或冷板。
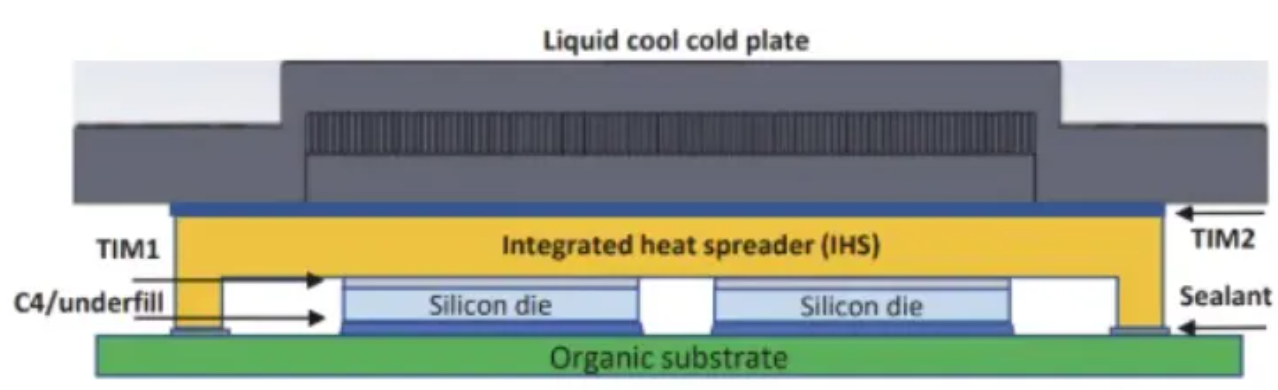
从两个角度来看,无论是芯片的内部的传热路径还是封装级由Lid-TIM-冷板,核心的问题还是界面的问题。整个传热的过程中涉及多层界面——硅衬底、金属互连、微凸块、底部填充、TIM等,由于这些分层的热界面,热量无法 100% 有效地传递到盖子上,从而导致局部“热点”。 这种累积热阻是限制芯片最大功率输出的主要因素之一。所以根据当前的芯片功耗的攀升,未来散热预计将从服务器级向芯片级演进,芯片级液冷有望成为未来主流。
04
关于微通道冷板
这一年里MLCP( Micro-Channel Liquid Cold Plate)大家都经常看到这个词,目前业内没有统一的定义。首先不考虑相变的前提下,我们沿用芯片级散热技术的三种类型(远端、近端、内嵌)来介绍液冷板的技术变化,整体的发展路线核心就是减少界面热阻。
(1)常规微通道液冷板
该路线是在传统冷板结构基础上,将内部流道的Fin的尺度进一步缩小,由传统毫米级缩小至 10–500μm 量级,使单位面积换热系数成倍提升。通过显著增加比表面积、缩短热扩散路径,在有限接触面积下承载更高热流密度。
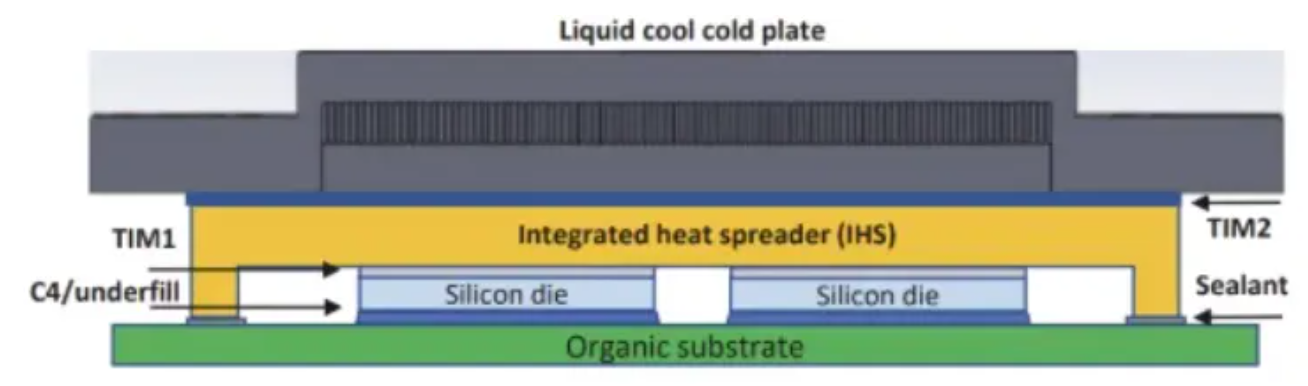
其制造核心集中在精密铲齿、微通道加工、扩散焊/钎焊、流道均匀性、气密性控制以及流体洁净体系,是当前国产替代窗口最明确的一条路径。
(2)微通道Lid/微通道水冷板(MLCP)
传统芯片封装上方的金属保护盖(Integrated Heat Spreader, IHS或Lid)与冷板进行融合形成一种微通道Lid。该路线直接将微通道刻入芯片封装 Lid 内部,使散热盖本身成为微流控换热器,液冷结构从系统级组件正式演进为封装级功能结构件。减少了TIM2,使得冷板与die之间只有TIM1。
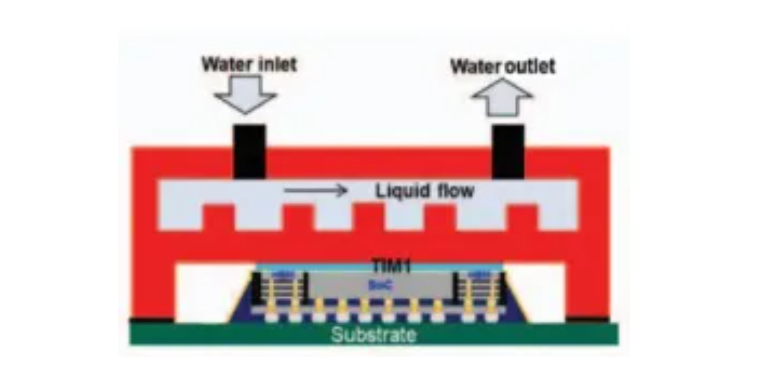
这个技术路线就是目前英伟达所提及的,当前英伟达给出的时间窗口为2027年下半年预计是Rubin的下一代版本,这一阶段仍处于工艺验证与供应链筛选期。
(3)VC微通道Lid(VC-MLCP-Lid)
在方案二的基础上把传统的Lid替换成VC的Lid,将冷板和VC进行结合。进一步优化改结构的热管理性能。
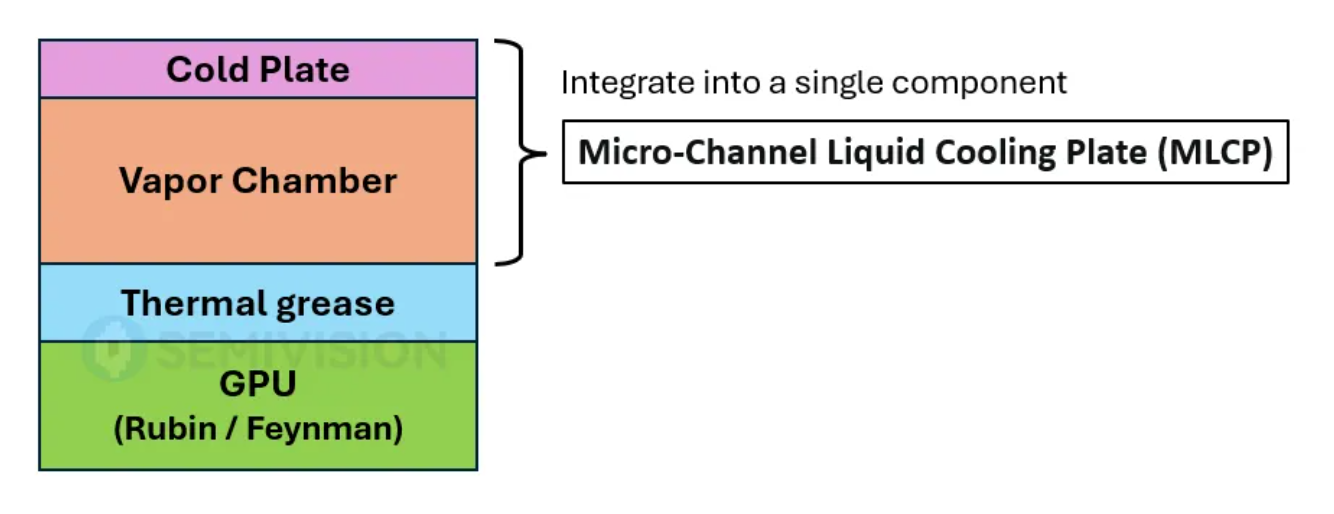
(4)嵌入式微通道冷板(Embedded Microchannel Plate)
嵌入式微通道冷板这一方案开始突破“冷板作为独立部件”的边界,将微通道结构部分嵌入到器件内部,使流体通道更靠近热源 Die,从而进一步缩短热阻路径。
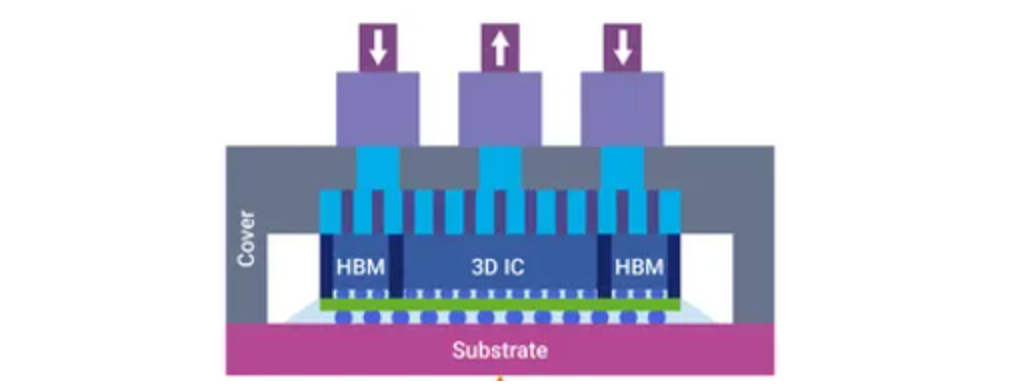
其技术特征是开始向半导体级加工精度靠拢,对蚀刻、LIGA、微结构等工艺提出更高要求,是液冷板从“机械加工件”向“微纳制造件”过渡的关键形态。
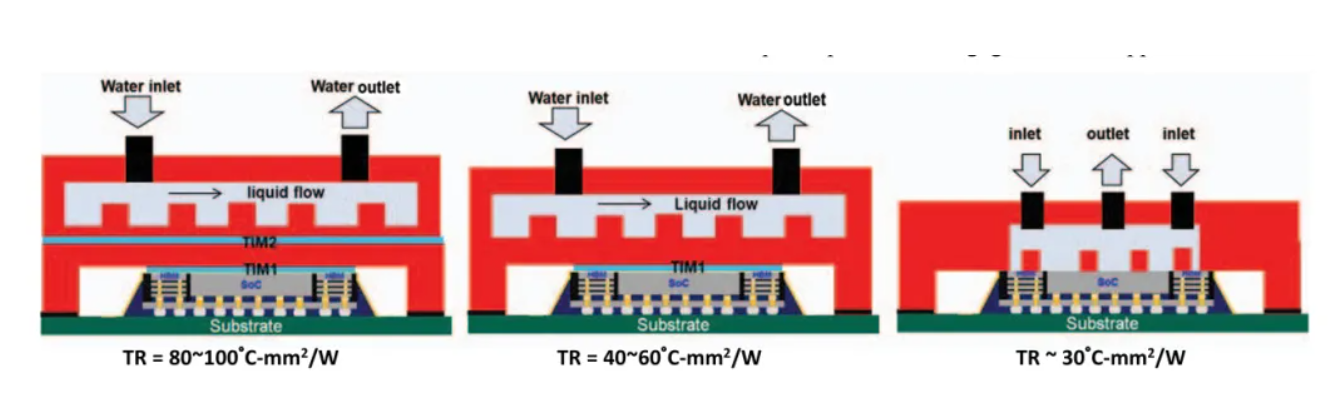
除此之外,其实目前为了解决芯片的热管理问题,配合液冷板的也有很多新材料和新设计方案的技术路线蓬勃发展。如冷板的材料本身有提出金刚石铜、石墨烯铜以及复合材料改性铜的新材料;也有两相液冷板以及微射流冷板等等。
你更认可未来那一条技术路线呢,欢迎评论区留下你的观察和见解!
05
最后
当芯片功耗持续走高,散热这件事其实已经不再只是“把热带走”这么简单了,它开始直接决定一整代算力架构能不能成立。微通道冷板、微通道 Lid、嵌入式微通道以及封装级液冷的连续出现,本质上是在把液冷一步步从服务器里的一个零部件,变成芯片结构的一部分。未来算力平台真正拉开差距的,不只是谁的制程更先进、谁的封装更复杂,而是谁能更早把“水刻进芯片里”。也正是在这样的技术拐点下,2026 热管理液冷板产业展所聚焦的微通道液冷、封装级液冷、新材料与先进制造,已经不再只是产品展示,而更像是一张提前展开的“下一代算力物理底座路线图”。下一代 AI 算力长什么样,也许就藏在这张路线图里。



