大阪公立大学给 GaN 器件 “贴” 金刚石:打造超强散热电子器件

来源 | IEEE Electron Device Letters
链接 | https://doi.org/10.1109/icsj66986.2025.11302700
01
背景介绍
随着高功率电子器件需求的不断增长,氮化镓高电子迁移率晶体管(GaN HEMT)在高频、高功率应用中发挥着核心作用。然而,随着器件功率密度和工作电压的不断攀升,器件的自热问题逐渐突出,传统的Si或SiC衬底在散热能力上已无法满足需求。因此,采用高热导率金刚石作为散热衬底,成为解决GaN器件自热问题、提高功率性能的理想选择。
02
成果掠影

近日,大阪公立大学的研究团队提出了一种创新的金刚石/氮化物键合技术,成功提升了GaN HEMT器件的散热性能。通过表面活化键合(SAB)技术将 AlGaN/GaN/3C-SiC 异质结构转移到 CVD 生长的金刚石晶圆(含多晶金刚石 PCD)上,制备出GaN-on-金刚石 HEMTs,经最高 1100℃退火处理后,键合界面无剥离且非晶层再结晶,热边界电导显著提升,其热阻仅为 GaN-on-4H-SiC 和 GaN-on-Si HEMTs 的约 1/4,自热效应被最大程度抑制,同时展现出更优的电学特性(如更大漏极电流和跨导、更小负微分电导),且已实现 10mm×10mm、1 英寸及 2 英寸晶圆尺寸的器件制备,为高频高功率氮化物器件的散热优化提供了极具潜力的解决方案。研究成果以“Wafer Bonding of Diamond for Improving Heat Dissipation of Properties of Nitride Devices”为题发表在《IEEE Electron Device Letters》期刊。
03
图文导读

图1.未退火、600℃、800℃、950℃及1100℃退火后氮化物/金刚石接合处的图像,以及1100℃退火后氮化物/金刚石接合处的自组装单分子层(SAM)图像。
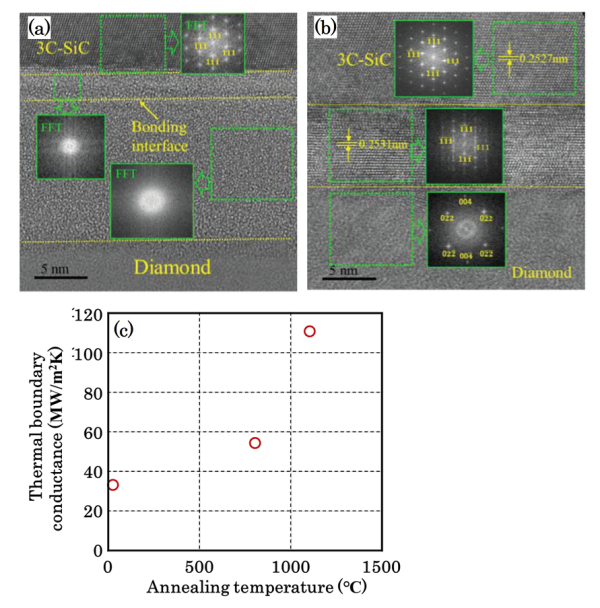
图2. (a)和(b):(a)刚键合状态与(b)1100℃退火处理后的3C-SiC//金刚石键合界面高分辨率透射电子显微镜图像。(c):采用热导瞬态响应法测得的3C-SiC//金刚石键合界面热边界导电率与退火温度的关系曲线。

图3. 用于制备金刚石基GaN高电子迁移率晶体管的示意性工艺步骤。
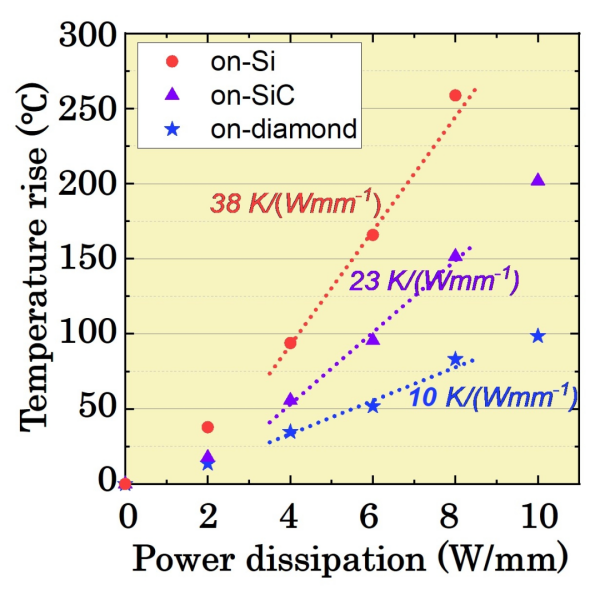
图4. LG = 5 µm且LSG = LGD = 10 µm的金刚石、4 H-SiC和硅上HEMT的栅漏间距栅极边缘温升与耗散功率之间的关系。还显示了每个HEMT的提取热阻。

图5.(a)液体冷却平板模型,(b)数值模拟和实验结果的比较。
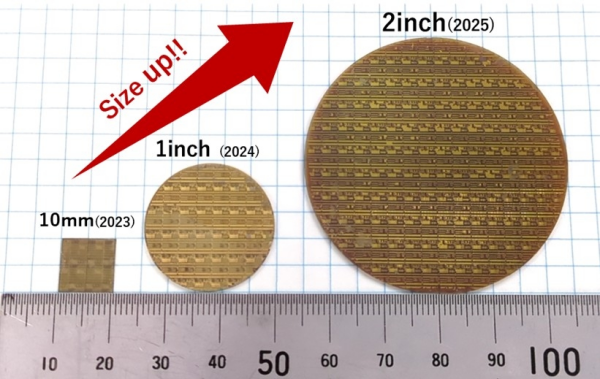
图6.在10 mm × 10 mm、1英寸和2英寸PCD晶片上制造的GaN HEMT 。


