又一热管理企业完成A轮融资!押注“VC微通道液冷盖板”

[洞见热管理]获悉,近日全球首款商业应用于芯片散热的高结构强度均温板(简称VC)研发企业中山市仲德科技有限公司(下称“仲德科技”)宣布完成数千万元A轮融资。本轮融资由乾融资本领投,长石资本跟投,老股东东莞智富继续追加投资,独木资本担任独家财务顾问。融资资金将主要用于扩大产能,以满足2026年批量交付订单的需求。

作为专注于高结构强度VC研发与生产的企业,仲德科技核心业务覆盖从AI芯片端到数据中心服务器端的全链条热管理解决方案,业务范围贯穿芯片封装级到系统级散热需求。此次融资不仅是资本对其技术实力的认可,更凸显了AI算力爆发背景下,高端散热技术商业化的迫切需求。据了解,仲德科技在2023年和2024年已连续获得千万级融资,资本持续加注背后,是散热技术在AI产业中的战略价值不断提升。
01
核心产品
面对AI芯片功耗激增带来的散热挑战,仲德科技构建了两大核心均温板产品系列,全面覆盖芯片封装与散热模组两大关键环节。
第一系列聚焦芯片先进封装层面,包括均温盖板(VC-Lid)及均温微流道液冷盖板(VC-MLCP-Lid),核心功能是替代传统封装盖板,直接适配芯片封装级散热需求。该系列产品在传导热性能及结构强度测试中获得国内外客户高度认可,预计2026年进入量产,有望成为芯片封装散热领域的行业新标杆。
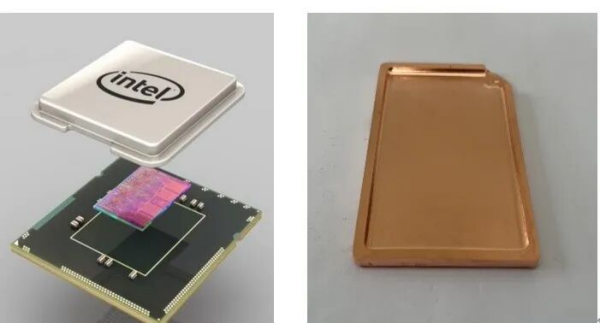
图 左图为传统芯片封装盖板,右图为仲德科技开发的芯片封装VC-Lid
第二系列为应用于散热模组级的高结构强度均温板(HSS VC),是风冷散热模组及未来液冷模组的核心传热部件。相较于传统产品,该系列产品在结构强度上实现跨越式突破,在多个客户测试中可承受600kg重压而不发生塑性变形,远超行业200-300kg的常规指标,而传统高温烧结均温板即便配备不锈钢加强筋也无法达到此标准。
目前,HSS VC已获得国际某头部交换机企业关于主交换机芯片及1.6T光模块散热模组的包产协议及批量订单,2026年有望斩获更多国际芯片及服务器企业订单。此外,仲德科技还在推进VC+液冷方案测试,旨在解决现有液冷模组挖热、均热不足的行业痛点。
02
核心技术:电化学3D打印技术
仲德科技均温板产品的核心竞争力源于其自主研发的“原子堆垛毛细结构”电化学3D打印技术。该技术彻底颠覆了传统VC的高温烧结制造工艺,实现了产品性能、生产效率与能耗的全面优化。
传统VC制造采用高温烧结工艺,需经过30余道工序,生产周期长达5-7天,不仅高耗能,且性能已触及天花板,结构强度差,无法适配AI芯片的高功率散热需求。而仲德科技的电化学3D打印技术通过可控工艺制造亚微米级毛细结构,大幅提升了吸液芯的孔隙率和毛细性能;同时采用激光焊封合,全制程无整体高温工序,既保留了铜材原始强度,又使导热系数较传统VC提升10-20%(数据仍在持续优化)。在生产效率上,该技术将生产周期缩短至90分钟以内,显著降低了生产能耗。
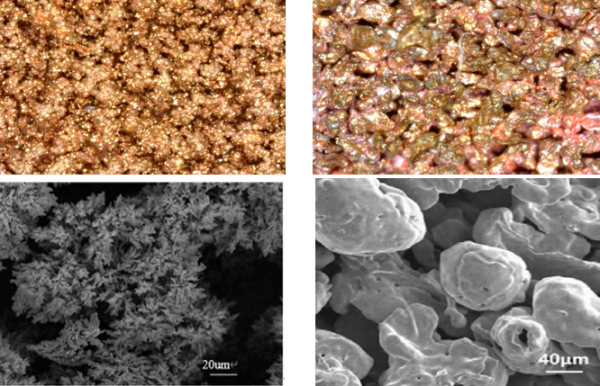
图 原子堆垛毛细结构与烧结铜粉毛细结构工艺比较
目前,仲德科技第三代“原子堆垛毛细结构”技术已进入量产阶段,第四代技术处于研发后期,通过优化工艺、电解液配方及微观结构,将进一步提升毛细性能,以应对更高功率芯片的热流密度需求。作为全球首家将该技术推向产业化应用的企业,仲德科技凭借这一核心技术确立了行业先发优势。
03
电化学3D打印热管理应用及进展
电化学3D打印虽属小众工艺,但在AI芯片热管理领域的优势正加速爆发,全球科技巨头与创新企业纷纷布局,行业活跃度持续提升。
国外方面,美国企业Fabric8Labs是电化学3D打印领域的知名企业,其技术已获得芯片巨头英特尔的高度关注与支持。在2025年年中举办的全球顶级电子热管理学术会议ITHERM配套大赛中,英特尔与Fabric8Labs联合支持赛事举办,而该赛事核心考核内容即包含电化学3D打印结构制造。同年10月底至11月间,英特尔风险投资部门联合另一家风投机构向Fabric8Labs注资5000万美元,这笔巨额投资凸显了巨头对该工艺在新型散热器领域应用潜力的认可。
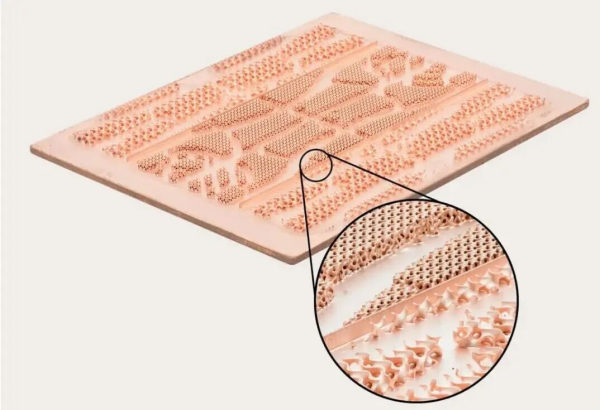
国内方面,除仲德科技外,其阳科技也在积极布局,与Fabric8Labs合作开发边缘人工智能系统热管理解决方案,通过电化学3D打印技术制造3D微网格板,应用于下一代网络平台,散热性能较同类产品提升超过1.3°C/100W。
此外,国内企业铂力特也在探索金属3D打印在热管理领域的应用,其展示的液冷板产品及高导热铝合金材料,为热交换领域提供了新的解决方案。

从行业格局看,仲德科技是全球首家将电化学3D打印制备的高强度均温板技术推向产业化的企业,而国内外企业的积极布局与资本加注,预示着电化学3D打印技术在热管理领域的商业化进程将加速推进。
04
总结
仲德科技此次A轮融资及产业化进展,为破解高端芯片散热难题提供了可行路径。其依托电化学3D打印技术的均温板产品,在结构强度、导热性能及生产效率上实现对传统产品的超越,已获得国际头部企业认可。投资方乾融资本指出,仲德科技的HSS VC可引领下一代可插拔光模块、服务器及交换机的散热应用,VC-Lid在芯片封装领域有望产生颠覆性影响;长石资本则认为,新型VC的高性价比优势适配了芯片散热的迫切需求,VC-Lid替代传统封装盖板将成为半导体领域发展趋势。
