从材料到微泵,锐盟半导体重塑主动式热管理
01
介绍
近日,作为AI时代芯片级主动式散热领导者,锐盟半导体再获毅达资本、合创资本数千万元人民币pre-A+轮投资,由跃为资本担任独家财务顾问。这是锐盟半导体一年内斩获的第三笔融资,年度融资规模已逼近亿元,充分彰显资本市场对其技术路线与市场前景的高度认可。
作为国内稀缺的垂直整合型微系统方案商,锐盟半导体自2020年成立以来,构建了完整的“材料-器件-芯片-算法”技术闭环。其自研压电材料体系关键指标显著超越行业基准,赋能革命性产品Magic Cool散热微泵实现毫米级厚度与工业级散热效能的突破性平衡,使锐盟跻身全球固态主动散热技术第一梯队,与国际企业一道共同推动行业革新。
锐盟半导体正加速推动智能终端及高算力芯片级主动式散热微系统迈向规模化商用,目前,公司已与多家头部终端进行量产项目的深度合作,即将实现批量出货,直击AI算力爆发的核心散热瓶颈。
02
AI终端算力爆发,散热成性能释放关键瓶颈
高通公司《AI变革正在推动终端侧推理创新》白皮书显示,随着百亿参数大模型落地手机端,端侧AI推理负载较传统应用激增10倍以上。以搭载第三代骁龙8s处理器的旗舰机型为例,其NPU算力达50TOPS,功耗密度同比提升40%,运行Stable Diffusion等生成式模型时,CPU与GPU协同功耗瞬间突破8W,机身温度15分钟内飙升至45℃,触发强制降频,导致实时AI处理、语音交互等功能卡顿。

每年发布的大规模AI模型数量趋势(按参数量分类),来源: Epoch AI
这一挑战带来了三大核心矛盾:
算力密度与散热效率失衡:终端侧大模型参数规模从10亿级跃升至100亿级(如LLaVA-1.5),单芯片峰值算力需求提升300%,但3nm制程芯片的漏电流问题使静态功耗同步增加,形成 “算力越高、发热越烈” 的困境;
极致轻薄化挤压散热空间:折叠屏手机、AR 眼镜等设备将内部空间压缩至极限,传统VC均热板等被动方案的可部署面积甚至不足2000mm2,热扩散路径被严重限制;
持续高负载场景的刚性需求:AI拍照HDR合成、手游实时渲染等高频场景要求设备长时间满负荷运行,被动散热的 “热饱和” 问题导致性能波动,用户体验下降。
台积电3DVC技术
为应对日益严重的高热量密度,全球主要玩家各显神通。台积电的3DVC(3D Vapor Chamber,三维均热板)技术是一种针对高性能计算和AI芯片的先进散热解决方案,旨在解决先进制程(如3nm/2nm)芯片因集成度提升导致的功耗和发热密度激增的问题。传统均热板是二维平面结构,而台积电的3DVC通过立体化设计,在芯片封装内部直接集成多层微流体通道,利用相变传热(液体蒸发-冷凝循环)快速导出热量。
英伟达“Double Flow Through(双流式)”散热方案以及机架级液冷设计
英伟达“Double Flow Through” 散热方案使用3D均热板搭配5根热导管,热导管紧密贴合在高密度PCB上并向两侧外部延伸,连接到绵密的散热鳍片。鳍片前后无遮蔽物,两颗风扇可直接对鳍片吹拂,气流能够顺畅地穿越鳍片至显卡后方,最大化气流穿越度,使废热不易堆积。其机架级液冷系统核心技术包括独立液冷板设计、相变浸没式液冷以及液冷与硅光子技术的协同进化,散热效率较传统冷板式再提升30%。
03
被动散热达物理极限,主动散热成必经之路
当前主流旗舰手机的散热方案仍依赖 “石墨/石墨烯+ VC均热板” 组合,即便散热组件总面积超6200mm²、在高负载游戏中机身温度也会突破47℃。被动散热的物理极限由 "热量自然传导" 的本质决定,其计算方式为:散热功率=热流密度×散热面积。
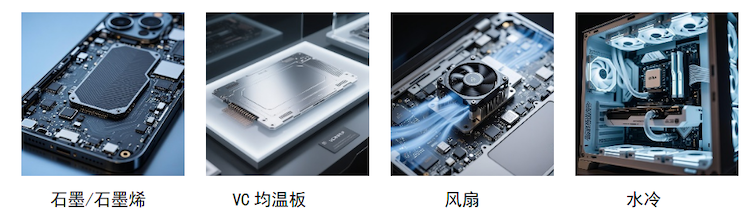
以手机为例,在当前屏幕与外壳材料条件下,当表面温度需满足国标要求的45℃时,自然对流散热的热流密度为0.01W/cm²,手机有效散热面积一般约为300-400cm²。因此当芯片功耗超过5W时,若不采用主动式散热技术,手机表温依旧会持续升高。有数据显示,厚度小于8mm、持续功耗高于6W的设备,被动方案已无法将结温控制在安全阈值内,而2025年AI手机的典型功耗已达8-10W甚至更高,主动散热技术成为刚需。

不同散热方式表面热流密度对应的温升曲线示意图
传统机械风扇的三大痛点,倒逼固态技术革新
早期采用的机械风扇方案虽能提供一定的散热能力,但在超薄设备中暴露致命缺陷:
空间占用与轻薄化冲突:首先传统风扇厚度普遍≥3.5mm,其次加上风道设计需占用超1000mm³空间,相当于牺牲300mAh电池容量,与轻薄终端续航优化方向背道而驰;
可靠性与寿命短板:机械轴承易受粉尘、振动影响,在实际应用中随使用时间增加故障率飙升;
噪音体验不佳:风扇转速超过5000RPM时噪音极其明显,在视频会议、夜间使用等场景中形成明显干扰,而高转速同样也会引发显著的功耗提高。
这些痛点使得机械风扇难以适配厚度≤7mm的超薄手机、AR眼镜等新兴终端,行业急需更微型化、可靠的主动散热方案。
05
固态压电风扇破局:国际标杆验证赛道潜力,锐盟全栈自研构建差异化优势
全球领先企业Frore Systems作为固态散热技术先驱,其AirJet Mini已应用于索泰迷你PC, AirJet PAK方案可支持100TOPS算力设备,公司累计融资超2亿美元。同样,另一家代表性企业xMEMS 发布了XMC-2400 µCooling™芯片,首款全硅微型气冷式主动散热芯片,专为超便携设备和下一代人工智能(AI)解决方案设计。
作为中国本土创新企业,锐盟半导体是少数实现从材料到工艺、从器件到流体结构、从芯片到算法全栈自研的国内企业。其自研的PZT压电陶瓷体系,压电系数较传统材料提升20%,能量转换效率提升35%,同等体积下换热系数增强40%。
锐盟半导体推出的MagicCool散热微泵集成自研驱动SoC芯片,在100mm2*2mm的尺寸下流量达2 L/min、功耗仅200 mW,背压达420 Pa、换热系数达330 W/(m^2*K)。搭配AI动态调节算法,可根据负载实时优化散热功率,平衡效能与噪音。目前,锐盟的固态压电散热方案已进入多家头部手机厂商供应链,即将随客户旗舰机型量产。
05
行业展望:从散热革命到智能执行生态
随着AI终端从 “硬件堆砌” 转向 “体验深耕”,散热技术正从幕后支撑变为显性竞争力。最新市场调研报告显示,2025年全球散热市场规模将突破千亿美元,年复合增长率保持10%以上。锐盟半导体凭借全栈自研能力与场景化创新,填补了国内固态压电散热的技术空白,以 “中国方案” 参与全球竞争,其技术正从3C、手机拓展至多领域应用场景,推动智能设备在算力、续航、轻薄化上的体验持续突破,成为AI时代终端创新的底层核心支撑技术提供者。
