中南大学:铟基热界面材料抗老化新方案
来源 | Journal of Materials Research and Technology
链接 | https://doi.org/10.1016/j.jmrt.2025.04.242
01
背景介绍
热界面材料(TIM)广泛用于填充界面间隙和降低热阻。其中,铟由于其高导热性、优异的剪切强度、低拉伸强度和低熔点而成为理想的金属TIM ,为了确保铟和散热系统之间的有效结合,芯片背面和盖内表面都被金属化。芯片背面通常具有Au/Ni/Ti三层系统,其中Au层用作润湿层,而Ni和Ti层分别用作扩散阻挡层和粘附层,关于盖,其通常采用具有内部Au/Ni双层的Cu衬底,界面键合反应通常导致金属间化合物(IMC)的形成,这表明有效的界面连接。然而,由于其脆性,IMC的过度生长会导致可靠性问题。因此,铟与各种涂层之间的界面反应的系统分析对于评估微电子封装中铟TIM的可靠性至关重要。
02
成果掠影

近日,中南大学汪炼成、朱文辉团队,通过等温老化试验评价微电子封装可靠性,模拟材料在不同使用条件下的性能演变。重点研究了铟热界面材料与金属界面之间的固-固反应特性,以In/Au/Ni(P)/Cu体系为研究对象,系统地表征了界面金属间化合物的形貌演化规律,通过建立In/Au/Ni/Cu体系在150 ℃时效的对照实验,证实了Ni(P)层可以显著提高倒装芯片球栅阵列(FCBGA)封装中铟基TIM在高温工作条件下的长期可靠性,并通过现有生产线验证了其工业可行性。研究结果可为含涂层的IMC的制备提供一定的参考铟TIM在FCBGA封装中的应用。研究成果以“Effect of P on interfacial reaction and shear strength for FCBGA packaging with indium thermal interface materials under isothermal aging”为题发表在《Journal of Materials Research and Technology》期刊。
03
图文导读
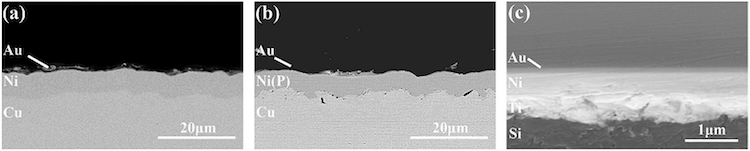
图1. Au/Ni/Cu (a)、Au/Ni(P)/Cu (b)和Au/Ni/Ti/Si (c)体系的截面SEM显微照片。
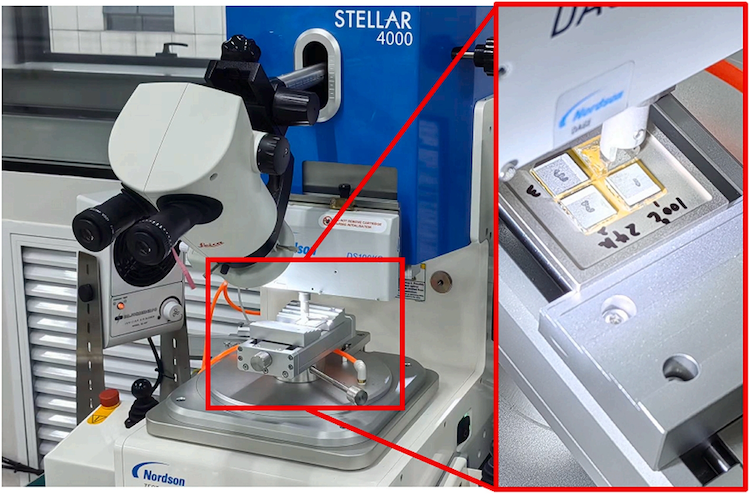
图2. STELLAR 4000剪切试验机。
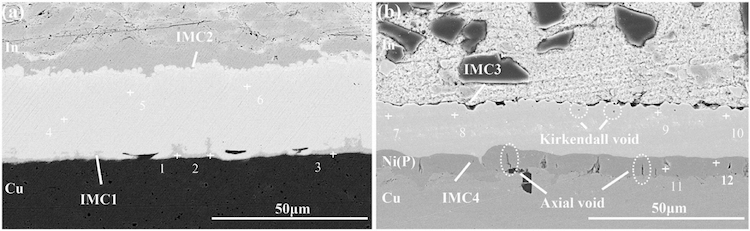
图3.显示(a)In/Au/Ni/Cu和(B)In/Au/Ni(P)/Cu多层体系在150 ℃等温老化1000 h后界面演变的横截面SEM显微照片。
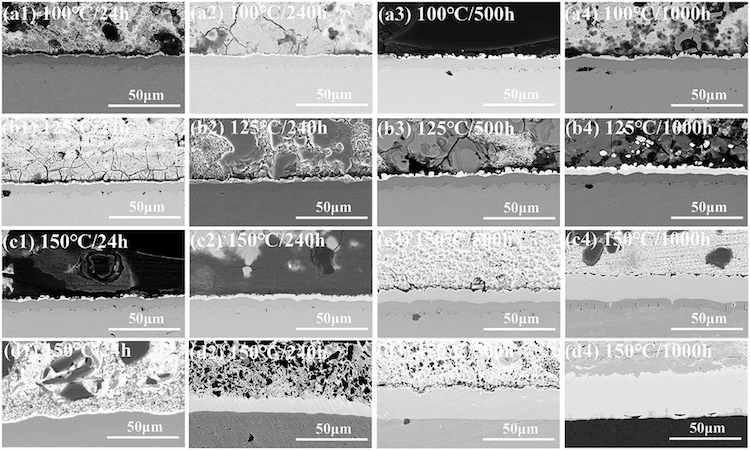
图4. In/Au/Ni(P)/Cu体系在(a1-a4)100℃、(b1-b4)125℃、(c1-c4)150℃以及In/Au/Ni/Cu体系在(d1-d4)150℃下老化24-1000小时后的界面演变截面SEM显微照片。
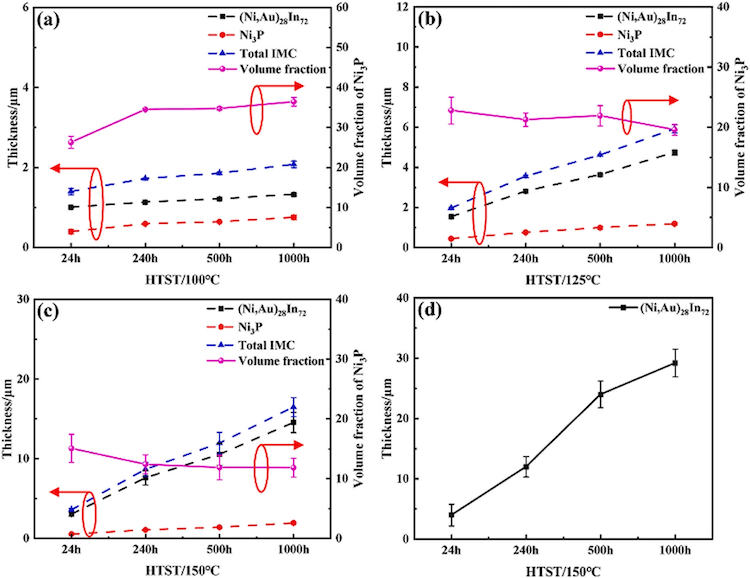
图5. 等温老化过程中金属间化合物(IMC)厚度演变的统计分析:(a)-(c) In/Au/Ni(P)/Cu界面的相厚度分布;(d) In/Au/Ni/Cu界面的相厚度分布。

图6. (a)-(b) In/Au/Ni(P)/Cu体系中(Ni, Au)28In72相及(c)-(d) Ni3P相在等温老化过程中的生长动力学平方根与自然对数关系。

图7. In/Au/Ni(P)界面表征结果:(a)(c)截面SEM图像;(b)(d)对应的EDS线扫描元素成分分布。
