芯片发热怎么办?芬兰科学家把“夹心层”换成了氮化铝
来源 | Advanced Electronic Materials
链接 | https://doi.org/10.1002/aelm.202500175
01
芯片太热了,问题可能出在“夹心层”
在我们用的手机、车载系统、智能家电中,很多核心芯片其实并不是“传统”意义上的硅芯片,而是一种叫做“绝缘体上硅”(Silicon-on-Insulator,SOI)的结构。它就像是把一块硅片夹在“夹心饼干”中间:上层是芯片工作区域,下层是支撑基底,而中间那层“夹心”——叫作埋层氧化硅(BOX)——负责电气绝缘。
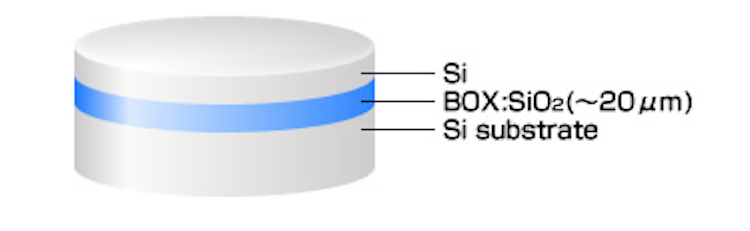
与传统硅基工艺不同,SOI晶圆由三层结构组成:顶部为单晶硅层(用于制造晶体管),中间为二氧化硅绝缘层(埋氧层),底部为硅衬底。这种结构通过物理或化学方法将硅层与衬底隔离,形成独立的电学环境。SOI技术的核心在于利用绝缘层阻断电流泄露路径,从而显著降低器件功耗,同时提升抗干扰能力。该技术自20世纪80年代进入工业化阶段以来,已成为先进制程的重要分支。这种设计有很多好处,比如更省电、不容易串电、也能做得更小、更快。
但它也有一个大麻烦,热出不去。
这个“夹心层”虽然电性很好,但导热性能却非常差,仅仅只有空气的两倍左右(约1.4 W/m·K),远远低于硅本身。这意味着:芯片越用越热,热量却像堵在了瓶子里,出不来,温度飙升,性能下降,寿命缩短,甚至可能损坏。特别是今天的芯片早已进入“高热密度”时代,小小一块芯片上可能集成了几十亿个晶体管。温度,已成为决定芯片性能和稳定性的“看不见的杀手”。
有没有一种材料,既能像氧化硅一样电绝缘,又能像金属一样导热?
氮化铝是一种新兴的高热导绝缘材料,在某些情况下热导率甚至可以达到300 W/mK,是氧化硅的200多倍。而且它在高频、功率器件中也表现出极佳的稳定性。
不过,把氮化铝嵌进SOI结构中,并非易事——如何在硅上长出高质量的AlN薄膜?如何控制它的晶体取向和缺陷?如何避免界面热阻的“失分”?这正是Aalto大学这项研究要解决的问题。
02
AlN薄膜,让SOI平台热流“破局”

Aalto大学Josef Stevanus Matondang教授团队提出在SOI结构中引入高热导率的氮化铝(AlN)薄膜作为替代BOX的掩埋绝缘层,可望显著改善热散能力。研究通过三种不同工艺(ALD、反应溅射、MOVPE)在Si (111)衬底上沉积AlN薄膜,全面评估了它们的晶体结构、表面形貌、热导率和界面热边界电导(TBC)等参数。主要成果如下:
MOVPE AlN 薄膜热导率高达 230 W/mK,显著优于传统BOX;
TBC 最高达 240 MW/m²·K(溅射AlN/Si界面),表明界面热阻也能控制在较低水平;
通过修正的Williamson-Hall分析,首次建立了晶粒尺寸与热导率之间的强相关性;
MOVPE工艺优化后,AlN膜的表面粗糙度低至4Å,满足直接键合的工业要求。
研究指出,尽管AlN与Si界面仍存在数纳米厚的氮化硅非晶层,略微降低了TBC,但整体热阻已远优于传统SOI结构。该成果为构建“热友好型”SOI平台提供了新解法,有望在射频和功率器件等高功率应用中大显身手。研究成果以“Thermally Conductive Buried Aluminum Nitridefor Next Generation Silicon-on-Insulator”为题发表在《Advanced Electronic Materials》期刊。
03
图文导读
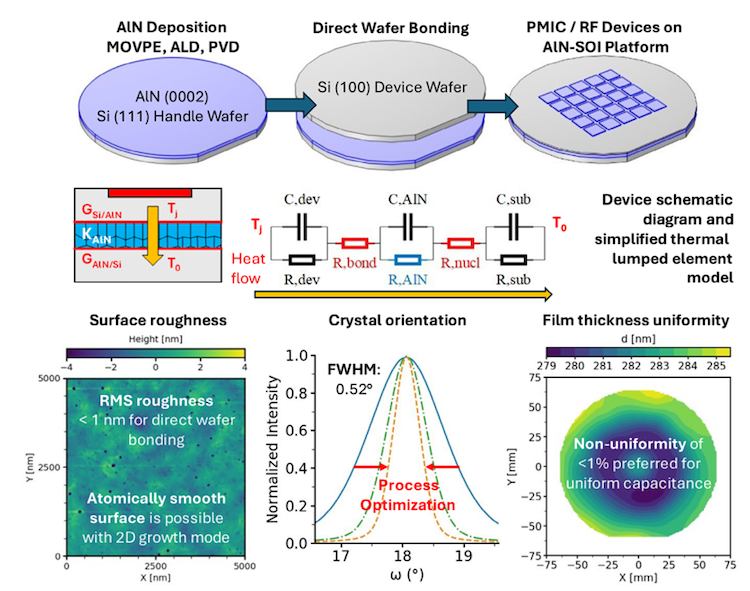
图1. 氮化铝绝缘体上硅 (AlN-SOI) 平台及其在薄膜沉积、晶圆键合和散热在应用方面的关键挑战。等效热电路表示从示例器件结温 (Tj) 到环境温度 (T0) 的跨平面一维热传导。
展示了AlN取代BOX的SOI架构横截面,并用“热等效电路”图形化表示从芯片结温Tj到环境温度T₀的垂直热流通道。AlN层和界面TBC被分别建模为串联热阻。
明确指出AlN替代SiO₂后的散热路径结构及瓶颈位置,提出了AlN膜与界面(核化面、键合面)TBC的两重关键热阻来源。
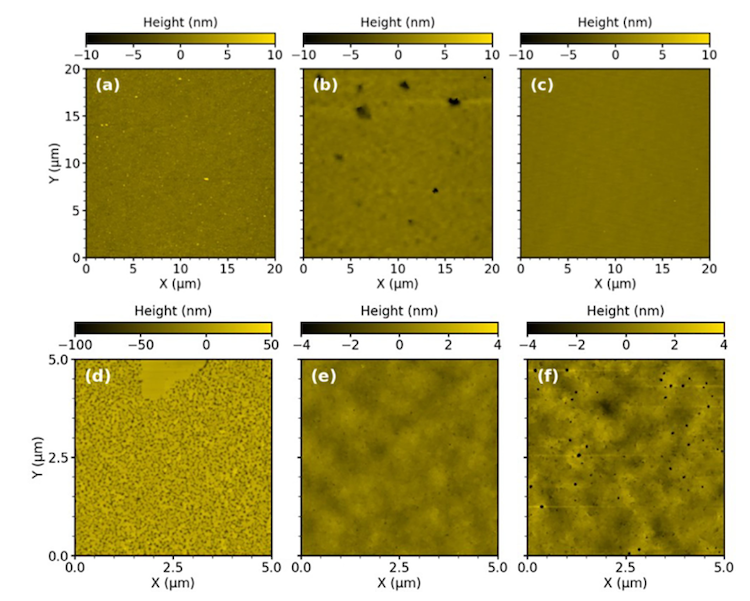
图2. 不同工艺制备的AlN薄膜表面形貌比较。
三种工艺(ALD、溅射、MOVPE)制备的AlN薄膜,在5×5μm扫描范围下的表面粗糙度图与参数(Sq)对比。MOVPE制得的样品虽然热性能好,但存在针孔/坑洞问题,优化后(MOVPE-1)粗糙度降至4Å,接近商业键合要求。
表面越平整,热界面越容易“贴合”,热阻越低;MOVPE-1达到4Å级粗糙度,是实现AlN-SOI直接键合的工艺门槛;
说明在提升导热性能的同时,不能牺牲机械/表面完整性。

图3.AlN薄膜的X射线衍射(XRD)分析
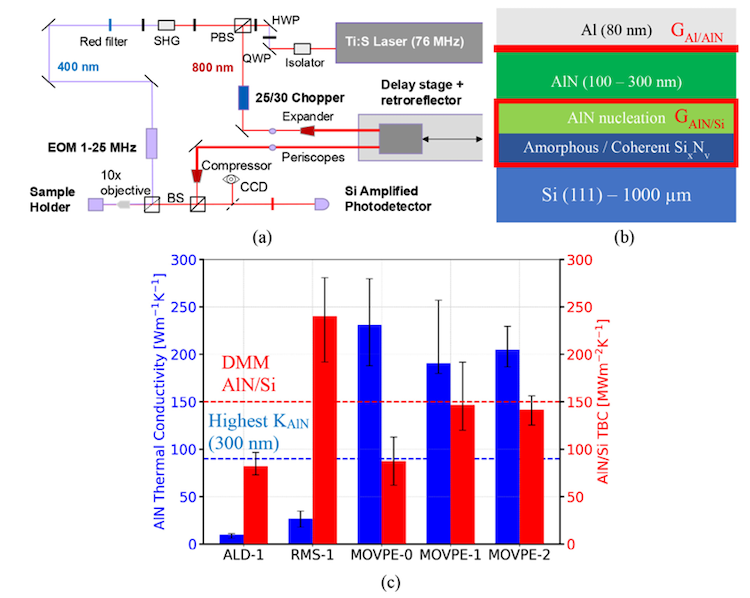
图4. 氮化铝的热特性表征
使用TDTR技术测得不同薄膜热导率和AlN/Si界面TBC:
ALD薄膜:9.7 W/m·K
溅射RMS-1:26.5 W/m·K
MOVPE系列:190–230 W/m·K;TBC从87~147 MW/m²·K不等。
MOVPE-AlN热导率首次大幅突破200 W/mK,部分样品甚至超过文献中最优值;然而TBC受“非晶界面层”影响较大,最优样品MOVPE-1 TBC为147 MW/m²·K,比溅射样品略低;说明在片内导热(热导率)提升的同时,界面工程(TBC)仍是制约散热效能释放的“临界点”。

图5. MOVPE-0与MOVPE-2样品的薄膜热导率与晶粒尺寸分析
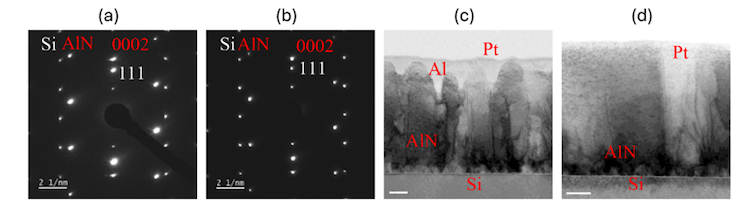
图6. AlN薄膜的晶体质量与晶粒尺寸对比
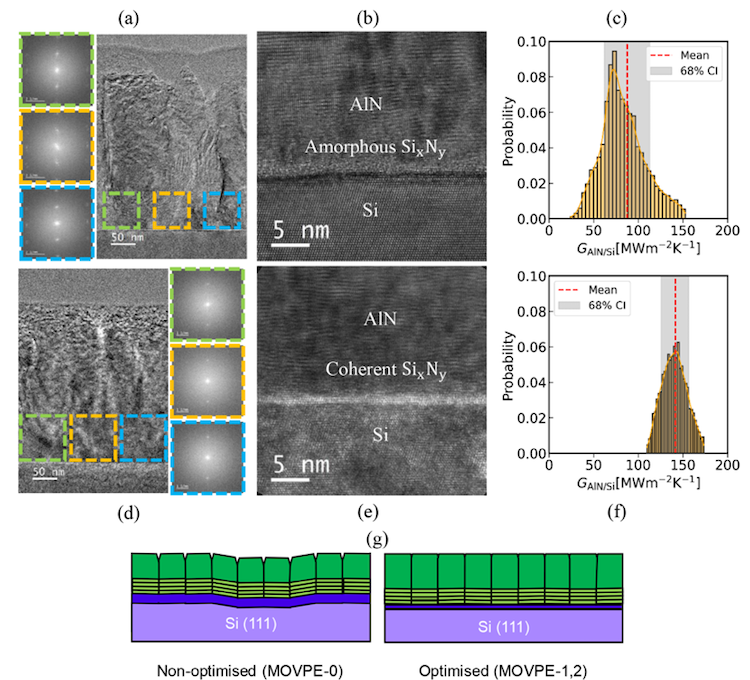
图7. AlN成核层晶体取向、AlN/Si界面质量与TBC比较

图8. 本研究中AlN薄膜性能对比分析
